用于取代IGBT的碳化硅(SiC)MOSFET 技術(shù)發(fā)展回顧
2019-11-01 13:16:35 原創(chuàng): Sinjin EETOP多年之前碳化硅的半導(dǎo)體器件潛力已為人所知。在1962年Lloyde Wallace獲得了專利(US3254280A),這是一種碳化硅單極晶體管器件。它本質(zhì)上是一個結(jié)型場效應(yīng)晶體管。圖1顯示了Lloyde 1962年專利的圖。在P型SiC主體中形成N型溝道區(qū)域。源極/漏極觸點形成到N型溝道。柵極結(jié)構(gòu)位于源極和漏極之間,并且相應(yīng)的柵電極位于SiC襯底的底側(cè)。目前,UnitedSiC正在生產(chǎn)基于碳化硅的JFET ,盡管它們是為了提高性能而基于垂直設(shè)計,其中源極和柵極位于SiC裸片的頂部,而漏極位于背面。

圖1從US3254280A(碳化硅單極晶體管)
1989年,北卡羅來納州立大學(xué)(NCSU)的B. Jayant Baliga首次描述了將SiC用于電力電子設(shè)備的好處1。Baliga在通用電氣期間發(fā)明了IGB。他現(xiàn)在是NCSU的杰出大學(xué)教授。他得出了一個稱為BHFFOM的品質(zhì)因數(shù),該品質(zhì)因數(shù)表明可以通過使用具有更大遷移率和更高臨界擊穿場的半導(dǎo)體(例如SiC甚至鉆石)來減少功率損耗。在這段時間出現(xiàn)了一系列與碳化硅的電力半導(dǎo)體應(yīng)用相關(guān)的專利。
當(dāng)時的主要發(fā)明者之一是約翰·帕爾默(John Palmour),他于1987年在北卡羅萊納州的三角研究園共同創(chuàng)立了Cree。現(xiàn)在他是電源和射頻技術(shù)的首席技術(shù)官。Cree一直是SiC功率器件技術(shù)的主要驅(qū)動力之一。當(dāng)他還在NCSU時,還是一名研究生,他在1987年申請了一項重要專利,該專利導(dǎo)致了SiC基MOSFET晶體管的發(fā)明。
該開創(chuàng)性專利(US4875083A)涉及在SiC襯底上形成MOS電容器結(jié)構(gòu)。
現(xiàn)摘錄1987年此項專利發(fā)表的簡介,描述了當(dāng)時SiC的發(fā)展?fàn)顩r:
然而,最近在這一領(lǐng)域取得了一些進(jìn)展,使商用優(yōu)質(zhì)碳化硅電子器件的生產(chǎn)首次成為可能。
本專利圖1和圖2展示了所述MOS電容器的結(jié)構(gòu),如下圖2所示。該電容器是由一個圓形歐姆接觸到摻雜的碳化硅襯底與中心圓形金屬接觸在一層氧化物。由于底層SiC中的載流子損耗,電容隨外加電壓的變化而變化。MOS電容結(jié)構(gòu)是形成MOSFET晶體管的關(guān)鍵。
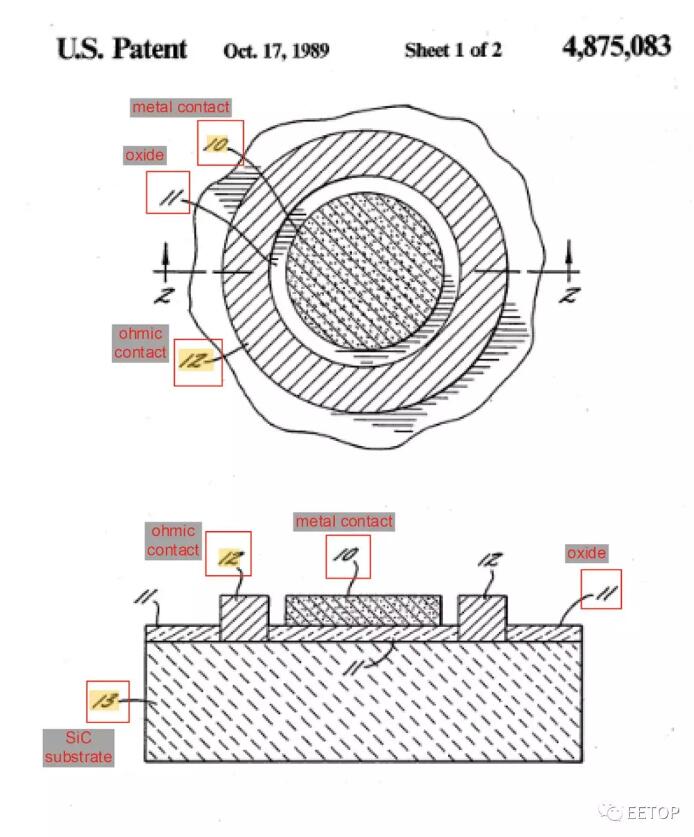
圖2: 來自US4875083A(在碳化硅上形成的金屬絕緣體-半導(dǎo)體電容器)
奇怪的是,在SiC襯底上,一個描述簡單的平面MOSFET晶體管的裝置專利似乎并不存在。很可能,這個概念在當(dāng)時會被認(rèn)為是顯而易見的,不需要申請專利。還有一些專利描述在碳化硅襯底上制造MOSFET晶體管的方法,描述了基本結(jié)構(gòu)簡單MOSFET結(jié)構(gòu)的變化。例如,Yoshihisa Fujii,Akira Suzuki和Katsuki Furukawa 在1990年提交US5170231A,描述了一種具有不對稱源/漏電導(dǎo)率的SiC MOSFET。此后不久,1992年,約翰·帕爾默(John Palmour)申請了開創(chuàng)性專利(US5506421A),描述了垂直溝槽柵極SiC MOSFET的結(jié)構(gòu)。該申請是在1996年批準(zhǔn)的,現(xiàn)在已經(jīng)超過20年了,因此該專利已經(jīng)過期,所描述的概念現(xiàn)在已經(jīng)進(jìn)入公有領(lǐng)域。但是,在此專利之后有許多與SiC MOSFET相關(guān)的專利仍然有效。例如,搜索顯示Cree擁有700多項與SiC MOSFET技術(shù)相關(guān)的有效專利。
US5506421A所示的垂直溝道SiC MOSFET的結(jié)構(gòu)如下圖3所示。該專利聲稱垂直功率MOSFET具有低導(dǎo)通電阻和高溫范圍,形成于碳化硅襯底的C面,類似于N型。在襯底上方形成N-漂移層,然后是P-溝道層。溝槽柵極穿透P-溝道層,并且形成N +源極區(qū)。金屬源電極和漏電極分別位于管芯的頂部和底部。這種溝槽架構(gòu)有時稱為UMOS(U形柵極),以區(qū)別于平面DMOS(漂移MOS)設(shè)計。
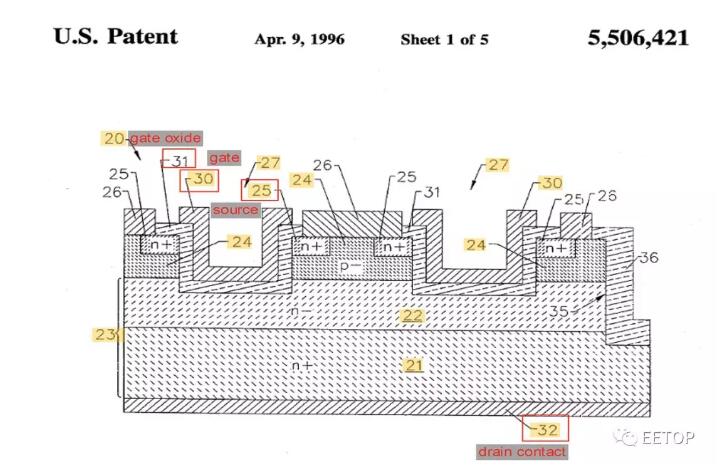
圖3 US5506421A(功率MOSFET在碳化硅)
到了2011年, Cree推出了市場上第一個SiC功率MOSFET,即CMF20120D器件。CMF20120D是垂直N溝道增強(qiáng)型SiC MOSFET。圖4顯示了CMF20120D器件中的平面晶體管柵極的橫截面SEM顯微照片。在此SEM顯微照片中描繪了N +源和P型身體植入物。
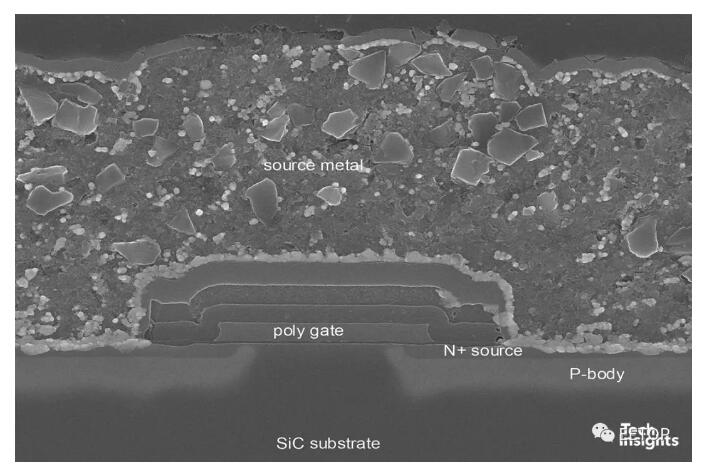
圖4 Cree CMF20120D碳化硅平面MOSFET橫截面
自2010年以來,碳化硅功率MOSFET市場顯著擴(kuò)大,現(xiàn)在每年超過2億美元。隨著SiC在汽車、光伏、鐵路等多個市場取代硅技術(shù),許多新的參與者已經(jīng)進(jìn)入市場,有望實現(xiàn)兩位數(shù)的復(fù)合年增長率。通常,SiC 功率MOSFET的工作電壓為1200或1700 V,旨在取代IGBT技術(shù)。最近發(fā)布了650 V SiC MOSFET器件,其目標(biāo)可能是與硅超級結(jié)和基于GaN的技術(shù)競爭。
看來Cree仍繼續(xù)專注于平面SiC MOSFET技術(shù)。但是,包括英飛凌和羅姆在內(nèi)的其他廠商在采用溝槽或UMOS技術(shù)。相比之下,意法半導(dǎo)體(STMicroelectronics)也專注于平面SiC MOSFET技術(shù)。圖5顯示了在羅姆 SCT3022AL 650 V SiCN溝道MOSFET 上發(fā)現(xiàn)的溝槽柵極的橫截面SEM顯微照片。
圖5與US5506421A的權(quán)利要求1的比較表明,羅姆 SCT3022AL使用了John Palmour精溝槽SiC MOSFET專利中的許多功能。例如,SEM圖像顯示溝槽,絕緣層和柵電極的存在。
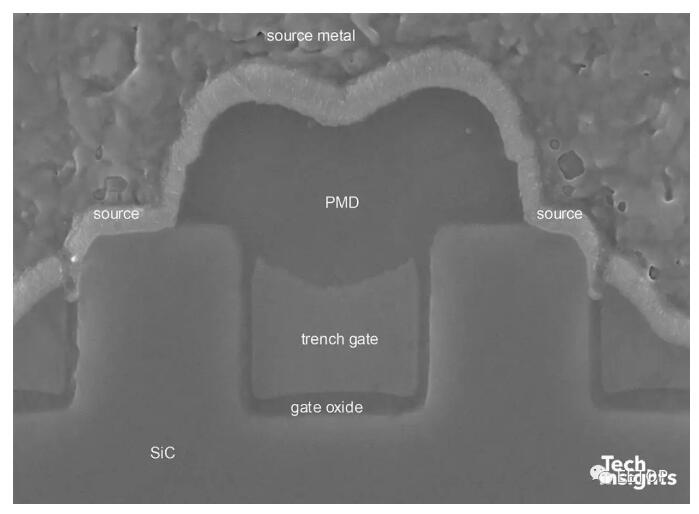
圖5 Rohm SCT3022AL 650 V SiC MOSFET橫截面
碳化硅是一種顛覆性的技術(shù),隨著在各種關(guān)鍵電力電子市場上它正在取代硅基技術(shù)的地位,正開始受到市場的關(guān)注。。自20世紀(jì)80年代中期以來,關(guān)鍵發(fā)明家所做的創(chuàng)新工作使這成為可能。據(jù)預(yù)測,到2025年,SiC電力電子市場規(guī)模將超過10億美元,并且可能會更早。

EETOP 官方微信

創(chuàng)芯大講堂 在線教育

半導(dǎo)體創(chuàng)芯網(wǎng) 快訊
相關(guān)文章