臺積電先進封裝大爆單!
2025-02-24 09:06:28 EETOP臺積電(TSMC)的先進封裝業務迎來了爆發式增長,業界傳出消息,英偉達(NVIDIA)已包下臺積電今年逾七成的先進封裝產能,這一動態引發了廣泛關注。
據業界透露,英偉達最新Blackwell架構GPU芯片需求強勁,這直接推動了對臺積電先進封裝服務的大量需求。英偉達選擇了臺積電的CoWoS-L先進封裝技術,該技術不僅讓芯片尺寸面積擴大,增加了電晶體數量,還可以堆疊更多的高頻寬記憶體(HBM),從而顯著提升高速運算效能。與先前的CoWoS-S及CoWoS-R先進封裝技術相比,CoWoS-L在效能、良率及成本等層面均表現出色,成為英偉達Blackwell架構芯片的主要賣點。
為了滿足英偉達等大客戶的需求,臺積電正在積極擴增先進封裝產能。臺積電董事長魏哲家此前已公開表示,公司正持續擴增先進封裝產能,以滿足客戶需求。臺積電統計數據顯示,2024年先進封裝營收占比約8%,預計今年將超過10%,并且目標是實現毛利率超過公司平均水準。
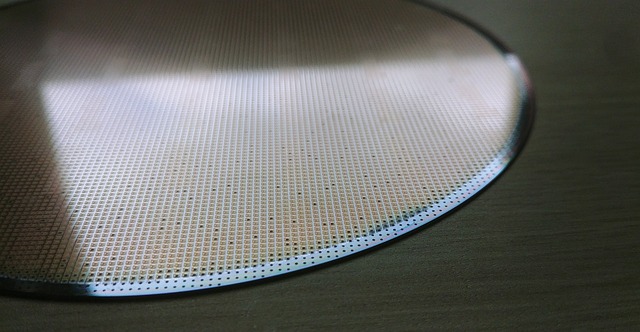
圖源:pixabay
英偉達對臺積電先進封裝產能的大舉包攬,也反映了AI芯片市場的強勁需求。隨著人工智能產業的快速發展,全球對GPU等AI芯片的需求持續攀升。英偉達作為全球GPU市場的領頭羊,其產品的需求量自然水漲船高。為了滿足市場需求,英偉達選擇與臺積電合作,利用后者的先進封裝技術來提升芯片性能和產能。
據悉,英偉達在Blackwell架構量產后,將逐步停產前一代Hopper架構的H100/H200芯片。這一世代交替的時間點預計在今年中,這也將進一步推動對臺積電先進封裝產能的需求。據供應鏈透露,英偉達統包了臺積電逾七成的CoWoS-L產能,預計全年出貨量將沖破200萬顆。
臺積電的先進封裝技術被稱為3D Fabric,并為此專門注冊了商標。3D Fabric技術涵蓋了InFO、CoWoS和SoIC三大類別,其中CoWoS技術尤為引人注目。CoWoS技術通過將多個具備不同功能的芯片先期封裝至硅轉接板上,借助該板上高密度的布線來實現芯片間的順暢互聯。隨后,整個構造再被精心安裝至更大的封裝基板上,以充分發揮其性能優勢。CoWoS技術涵蓋了CoWoS-S、CoWoS-R以及CoWoS-L等多種變體,以滿足不同應用場景的特定需求。