挑戰5nm單次曝光! ASML研發新一代Hyper NA EUV光刻機
2025-06-27 10:00:09 EETOP全球最大半導體設備龍頭ASML已著手研發下一代先進光刻設備,為未來十年的芯片產業做準備。該公司技術執行副總裁Jos Benschop向日經亞洲指出,這項技術足夠先進,可滿足2035年之后的制程需求。
Jos Benschop表示,ASML及獨家光學合作伙伴蔡司(Carl Zeiss)正在研究可在單次曝光中印刷出分辨率精細到5納米電路的機器設計,并補充這項技術將足以滿足2035年及之后的產業需求。
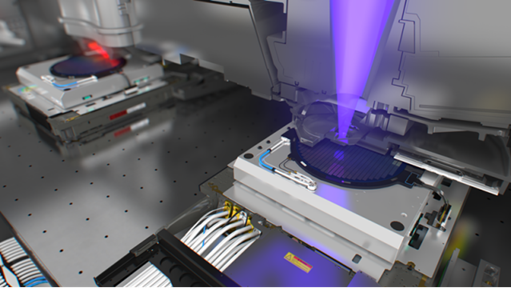
ASML 最近才開始出貨業界最先進設備,已可達到單次曝光 8 納米分辨率。 相較之下,較舊設備須多次曝光才能達到類似分辨率,不僅效率較低,制造質量也不一定。
Benschop指出,我們正與蔡司進行設計研究,目標是實現數值孔徑(NA)0.7 或以上的系統,目前尚未設定具體上市時間表。
數值孔徑(NA)是衡量光學系統收集與聚焦光線能力的關鍵指標,也是決定電路圖樣能否精細投影到晶圓上的關鍵因素。 當 NA 越大、光波長越短,印刷分辨率就越高。
目前標準EUV設備的NA為0.33,最新一代High NA EUV則提升至0.55。 而ASML正朝向NA 0.7或超高NA(Hyper NA)邁進,需要重新設計幾個關鍵系統。
ASML 目前已向英特爾、臺積電交付首批 High NA EUV 設備,不過 Benschop 表示,大規模采用仍需時間,產業界必須先驗證新系統的性能,并開發配套材料與工具,才能全面啟動,「這次新設備的導入與歷年來推出的創新工具情況類似,通常要幾年后才會進入大量產出階段。 客戶需要學習如何作,但我相信它很快會被用于高產能的芯片制造流程中“。