將激光集成到硅上的4種方法
2024-08-08 10:46:26 悅智網(wǎng) 作者:Roel 、Joris
RFTvoiaoFJw2ZcCrRP0qaFhVg/640?wx_fmt=gif&tp=webp&wxfrom=5&wx_lazy=1&wx_co=1" data-type="gif" data-w="300" data-original-style="outline: 0px;vertical-align: middle;width: 30px !important;visibility: visible !important;" data-index="3" src="http://www.xebio.com.cn/uploadfile/2024/0808/20240808104756641.jpg" _width="30px" crossorigin="anonymous" alt="圖片" data-fail="0" style=";padding: 0px;outline: 0px;max-width: 100%;box-sizing: border-box !important;overflow-wrap: break-word !important;vertical-align: middle;height: auto !important;width: 30px !important;visibility: visible !important"/>
在日常生活中,將一系列光電子功能集合在一塊芯片上的光子集成電路越來越常見,它們被用于連接數(shù)據(jù)中心服務(wù)器機(jī)架的高速光收發(fā)器(包括用于提供本刊網(wǎng)站的光收發(fā)器)、保持自動駕駛汽車正常行駛的激光雷達(dá)、發(fā)現(xiàn)大氣中化學(xué)物質(zhì)的光譜儀,以及許多其他應(yīng)用。所有這些系統(tǒng)都變得越來越便宜,并且在某些情況下,使用硅制造技術(shù)生產(chǎn)大部分集成電路也是經(jīng)濟(jì)可行的。
工程師們已經(jīng)能夠在硅光子芯片上集成幾乎所有的重要光學(xué)功能,包括基本的調(diào)制和檢測功能,但只有一種功能除外:光發(fā)射。硅本身無法有效地做到這一點(diǎn),因此人們通常利用III-V族材料制成的半導(dǎo)體(以其成分在元素周期表上的位置命名)制造單獨(dú)封裝的組件來發(fā)光。
如果可以在設(shè)計(jì)中使用外部激光二極管,那就沒有問題了。最近有幾個(gè)因素促使工程師們將激光與硅光子學(xué)結(jié)合起來。例如,可能沒有放置單獨(dú)光源的空間。植入體內(nèi)用于監(jiān)測血糖水平的微型設(shè)備可能就會面臨這個(gè)問題。或者,應(yīng)用的成本可能要求進(jìn)行更緊密的集成:當(dāng)我們可以在一塊硅晶圓上安裝數(shù)百或數(shù)千個(gè)激光器時(shí),相較于連接單獨(dú)芯片的情況而言,最終的成本會更低,可靠性也更高。
倒裝芯片集成
有一種簡單方法可以在硅晶圓上直接集成激光,這是一種名為“倒裝芯片處理”的芯片封裝技術(shù),從名字就可以知道它的原理。
芯片的電連接裝置位于頂部,最上層的互連在金屬焊盤處結(jié)束。倒裝芯片技術(shù)依賴的是附著在這些焊盤上的焊料球。然后將芯片翻轉(zhuǎn),使焊料與芯片封裝上的對應(yīng)焊盤對齊(在我們的情況中,則是與另一塊芯片對齊)。然后熔化焊料,將芯片連接到封裝上。
將激光芯片與硅光子芯片結(jié)合在一起的概念與之相似,但要求更嚴(yán)格。邊發(fā)射激光器會在晶圓上被完全加工,然后被切割成若干單獨(dú)的芯片,并由供應(yīng)商測試。然后,使用高精度的倒裝芯片工藝,一次一塊激光芯片,將單個(gè)激光芯片鍵合到目標(biāo)硅光子晶圓上。這個(gè)方法的難點(diǎn)在于確保在邊緣發(fā)射時(shí),激光器的輸出與硅光子芯片的輸入一致。我們會使用一種名為“對接耦合”的工藝,將激光器置于硅的凹陷部分,使其橫向鄰接硅光子波導(dǎo)管的蝕刻面。
為了實(shí)現(xiàn)這一點(diǎn),倒裝芯片工藝需要在全部3個(gè)維度上都達(dá)到亞微米的對準(zhǔn)精度。過去幾年里,我們開發(fā)了專門的倒裝芯片鍵合工具來完成這項(xiàng)工作,我們和合作者以及開發(fā)合作伙伴已經(jīng)使用了它們來優(yōu)化組裝過程。通過使用一種利用機(jī)器視覺來保持精確對準(zhǔn)的先進(jìn)拾放工具,我們可以在幾十秒內(nèi)放置和鍵合激光器件,且精度超過500納米。
2021年,我們還開發(fā)了一種晶圓級硅光子工藝來提高這種性能。這種工藝在硅芯片上添加了機(jī)械對準(zhǔn)基座和蝕刻精度更高的對接耦合接口,以實(shí)現(xiàn)優(yōu)于幾百納米的垂直對準(zhǔn)。借助這些技術(shù),我們在300毫米的硅光子晶圓上組裝了某些激光器件。我們高興地看到,來自每個(gè)器件的50毫瓦激光有多達(dá)80%被耦合到了它所連接的硅光子芯片中。即使在最壞的情況下,整個(gè)晶圓的耦合度仍然在60%左右。這些結(jié)果可與主動對準(zhǔn)所實(shí)現(xiàn)的耦合效率媲美,主動對準(zhǔn)是一種更耗時(shí)的工藝,該工藝?yán)脕碜约す馄鞅旧淼墓鈦硪龑?dǎo)對準(zhǔn)過程。
微轉(zhuǎn)印
微轉(zhuǎn)印消除了對接耦合的一些對準(zhǔn)困難,同時(shí)也加快了組裝過程。與倒裝芯片處理技術(shù)一樣,光發(fā)射器件被置于III-V族半導(dǎo)體基板上。但二者有一個(gè)很大的區(qū)別:III-V族晶圓并沒有被切割成若干單獨(dú)的芯片。相反,晶圓上的激光器進(jìn)行了底切,因此它們只能通過小系繩連接到源晶圓上。然后,一個(gè)像墨水印章一樣的工具會將這些器件一同拾起,斷開系繩。接下來,印模會將激光器與硅光子晶圓上的波導(dǎo)結(jié)構(gòu)對準(zhǔn),并將其鍵合。
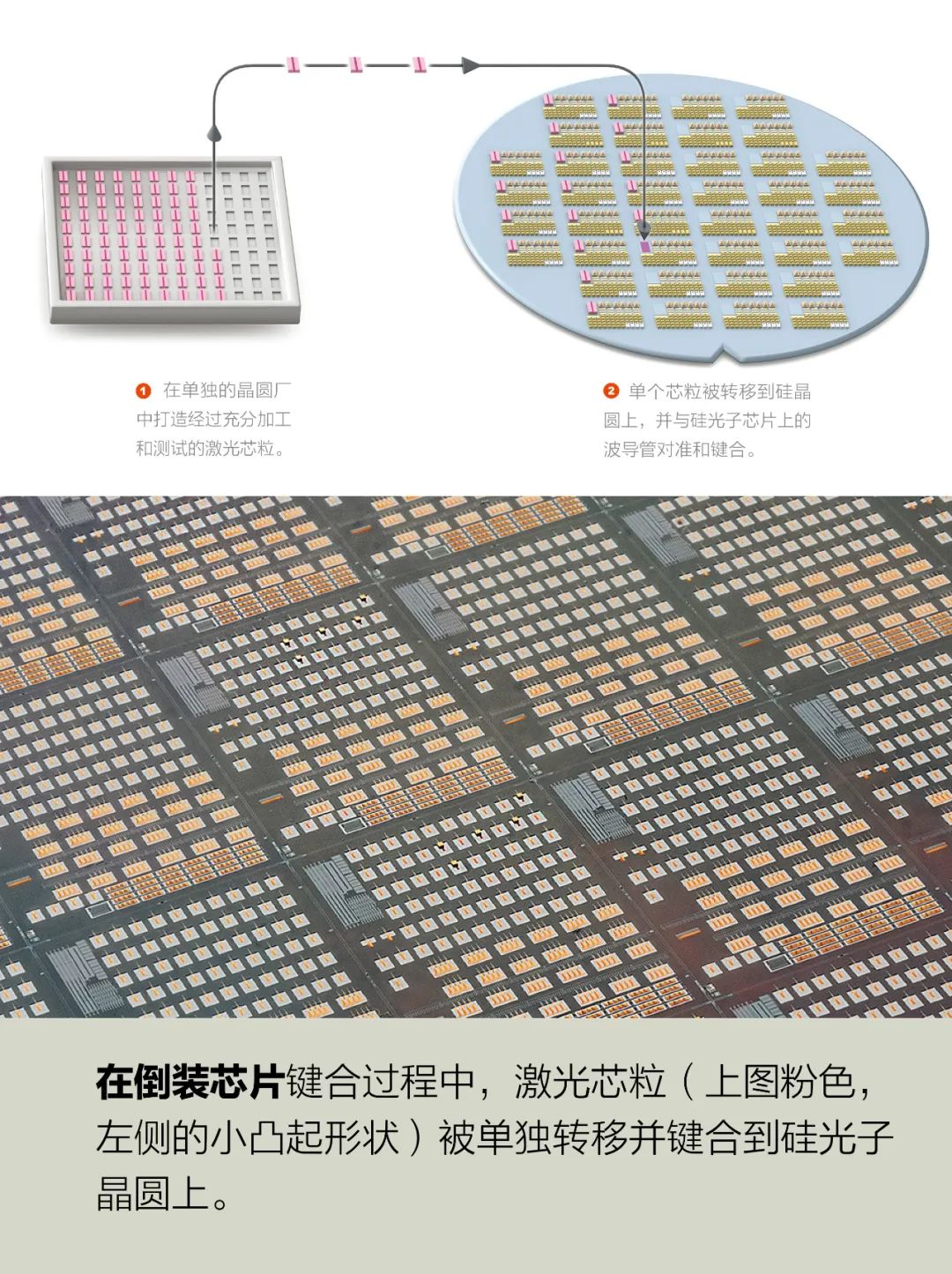
倒裝芯片技術(shù)使用的是金屬焊料凸點(diǎn),而微轉(zhuǎn)印技術(shù)使用的是粘合劑,甚至可以只使用分子鍵合,依靠兩個(gè)平面之間的范德華力來將激光固定到位。此外,硅光子芯片中的光源和波導(dǎo)管之間的光學(xué)耦合會通過另一種不同的過程發(fā)生。這一過程稱為“倏逝波耦合”,它會將激光放置在硅波導(dǎo)結(jié)構(gòu)的頂部,然后光線會“滲入”其中。雖然這種方式轉(zhuǎn)移的功率較小,但倏逝波耦合要求的對準(zhǔn)精度低于對接耦合。
這種技術(shù)具有更高的對準(zhǔn)容差,因而能夠同時(shí)轉(zhuǎn)移數(shù)千個(gè)器件。因此,原則上,它的產(chǎn)量應(yīng)該高于倒裝芯片工藝,并且非常適合需要每單位面積集成大量III-V族元件的應(yīng)用。
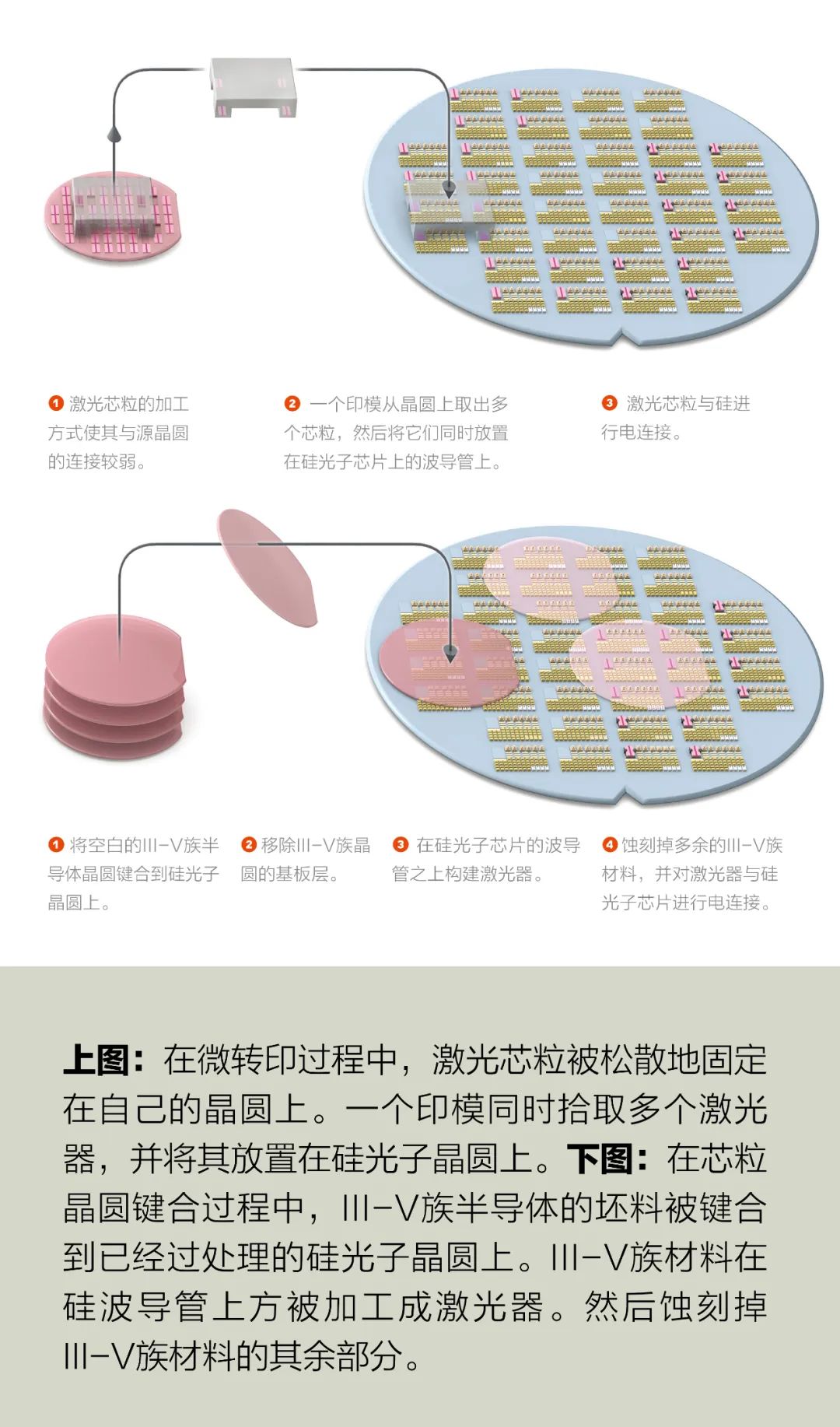
盡管轉(zhuǎn)印是制造microLED顯示器的既定工藝,例如許多增強(qiáng)現(xiàn)實(shí)和虛擬現(xiàn)實(shí)產(chǎn)品所需的顯示器,但這種技術(shù)還沒有準(zhǔn)備好用于打印激光器或光學(xué)放大器。我們正在努力實(shí)現(xiàn)這個(gè)目標(biāo)。
芯粒-晶圓鍵合
在我們討論的這兩種技術(shù)中,將發(fā)光元件與其硅光子伙伴進(jìn)行精確對準(zhǔn)是關(guān)鍵的一步。但有一種技術(shù)找到了解決這個(gè)問題的辦法,它就是III-V族硅晶圓鍵合。該方法不是將已經(jīng)構(gòu)建的激光器(或其他發(fā)光元件)轉(zhuǎn)移到處理過的硅晶圓上,而是將III-V族半導(dǎo)體的空白芯粒(甚至小晶圓)鍵合到硅晶圓上。然后,在相應(yīng)的硅波導(dǎo)管的位置上方構(gòu)建所需的激光器件。
在被轉(zhuǎn)移的材料中,我們只對晶體III-V族材料的薄層感興趣,該層稱為“外延層”。因此,在與硅晶圓鍵合后,剩余的材料會被移除。可以使用標(biāo)準(zhǔn)光刻和晶圓級處理工藝在外延層(與下層的硅波導(dǎo)管對準(zhǔn))中制造激光二極管。然后蝕刻掉任何不需要的III-V族材料。
這種方法是英特爾工程師在過去10年間開發(fā)的,光收發(fā)器就是第一款使用它打造的商業(yè)產(chǎn)品,于2016年推出。這種方法可以實(shí)現(xiàn)高產(chǎn)量集成,因?yàn)樗軌蛲瑫r(shí)并行處理許多器件。與轉(zhuǎn)印一樣,這種方法在III-V族和硅材料之間使用了倏逝波耦合,能產(chǎn)生高效的光學(xué)界面。
單片集成 
將所涉及的兩種不同材料結(jié)合在一起的理想辦法是直接在硅上生長III-V族半導(dǎo)體,這種方法稱為“單片集成”。這種方法不需要鍵合或?qū)?zhǔn),并可減少III-V族材料的浪費(fèi)。但要使這一策略切實(shí)可行,還需要克服許多技術(shù)障礙。因此,Imec等研究機(jī)構(gòu)還在繼續(xù)朝著這一目標(biāo)開展研究。
這項(xiàng)研究的主要目的是創(chuàng)造低密度缺陷的晶體III-V族材料。其根本問題在于,硅中原子的晶格間距與相關(guān)III-V族半導(dǎo)體中原子的晶格間距相當(dāng)不匹配,超過了4%。
由于這種晶格失配,生長在硅上的每個(gè)III-V族層都產(chǎn)生了應(yīng)變。只添加幾納米的III-V族薄膜,晶體就會開始出現(xiàn)缺陷,釋放出累積的應(yīng)變。這些“錯(cuò)配”缺陷會沿著穿透整個(gè)III-V族層的線形成。缺陷包括開放的晶體鍵線和局部晶體畸變,這兩種情況會嚴(yán)重降低光電子器件的性能。
為了防止錯(cuò)配缺陷徹底損壞激光器,必須將它們限制在遠(yuǎn)離激光器的位置。因此,通常需要鋪設(shè)一層幾微米厚的III-V族材料,在下面的缺陷和上面的無應(yīng)變區(qū)域之間形成一個(gè)巨大的緩沖區(qū),然后在該區(qū)域制造激光器件。加州大學(xué)圣芭芭拉分校的研究人員報(bào)告稱,這種方法取得了出色的進(jìn)展,證明了高效砷化鎵基量子點(diǎn)激光器具有良好的可靠性和壽命。
不過,目前這些實(shí)驗(yàn)只是小規(guī)模實(shí)驗(yàn),難以將這項(xiàng)技術(shù)擴(kuò)展到行業(yè)使用的200或300毫米晶圓。添加厚緩沖層可能會產(chǎn)生各種機(jī)械問題,例如在III-V族薄膜內(nèi)部形成裂紋或晶圓彎曲。此外,由于有源器件位于厚緩沖層之上,因此將光與硅基板的下層波導(dǎo)管進(jìn)行耦合頗具挑戰(zhàn)。
為了規(guī)避這些挑戰(zhàn),Imec引入了一種稱為“納米脊工程”(NRE)的單片集成新方法。該技術(shù)旨在將缺陷的形成囿于一個(gè)有限的空間中,從而得以在與底層硅交界的上方100納米多的地方構(gòu)建工作器件。
納米脊工程利用一種稱為“縱橫比陷阱”的現(xiàn)象將缺陷限制在了較小的區(qū)域。它首先在二氧化硅絕緣體層內(nèi)形成了窄而深的溝槽。在絕緣體與硅相遇的溝槽底部,在硅上切入一個(gè)凹槽,讓空隙的橫截面變成箭頭形狀。然后在溝槽內(nèi)生長一層薄薄的III-V族晶體,應(yīng)變引起的失配缺陷會被有效困在溝槽側(cè)壁,防止這些缺陷線進(jìn)一步滲透。溝槽被填充后,生長會繼續(xù)在溝槽上方形成更大的III-V族材料納米脊。納米脊中的材料完全沒有缺陷,因此可以用于激光器件。
硅激光器的前景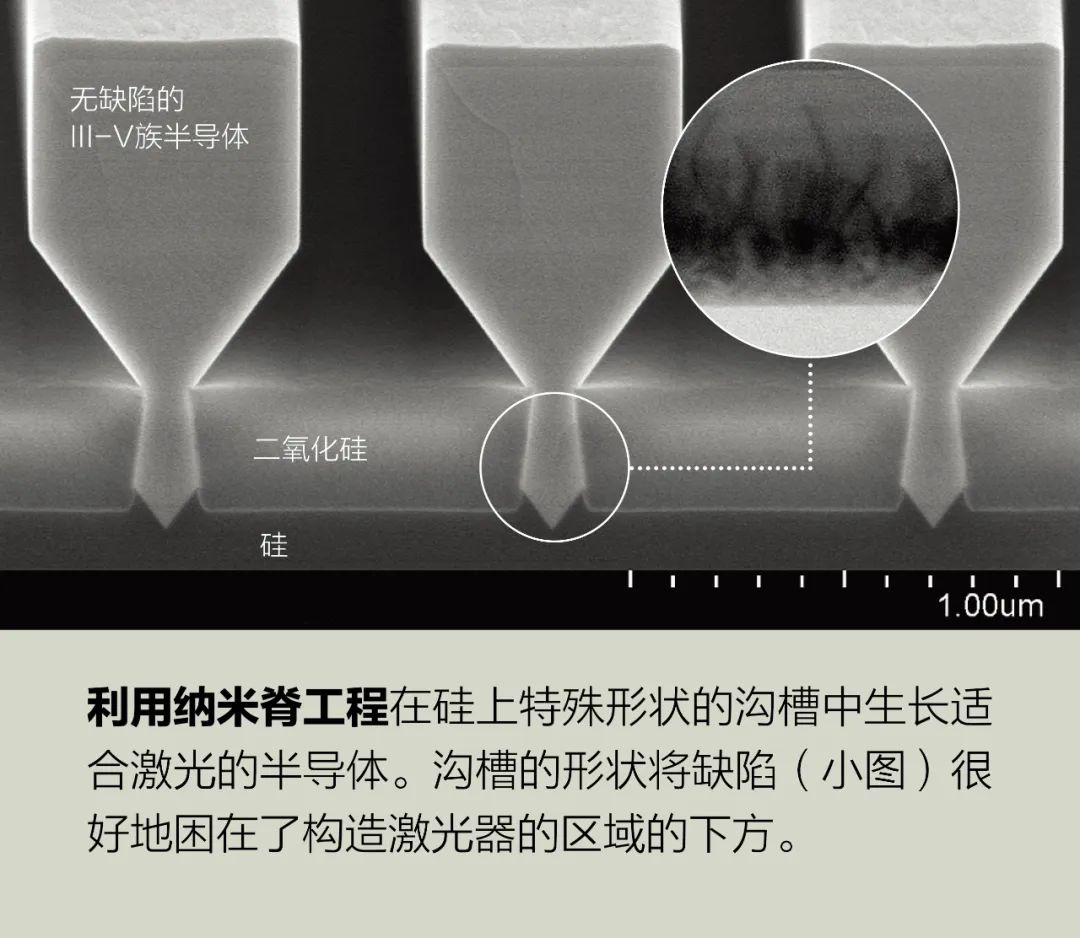

未來幾年,文中討論的每一種方法肯定都會進(jìn)一步發(fā)展。我們預(yù)計(jì)它們最終將共存,滿足不同的應(yīng)用需求和用例。
倒裝芯片激光器組件相對適中的安裝成本和準(zhǔn)備狀態(tài)將使近期產(chǎn)品的推出成為可能。該方法對于每個(gè)光子集成電路僅需一個(gè)或幾個(gè)激光器的應(yīng)用特別具有吸引力,例如數(shù)據(jù)中心使用的光收發(fā)器。此外,這種方法固有的靈活性也使其對需要非標(biāo)準(zhǔn)激光波長或罕見光子技術(shù)的應(yīng)用而言具有吸引力。
對于每個(gè)光子集成電路需要多個(gè)激光器或放大器的大容量應(yīng)用,轉(zhuǎn)印和芯粒晶圓鍵合方法則可實(shí)現(xiàn)更高的制造吞吐量、更小的耦合損耗,以及進(jìn)一步降低成本的可能性。因?yàn)榘惭b成本高得多,所以適合這兩種技術(shù)的應(yīng)用必須有很大的市場。
最后,硅上的直接III-V族外延附生(如納米脊工程技術(shù))代表了激光集成的最終水平。我們和其他研究人員必須在材料質(zhì)量和晶圓級集成方面取得進(jìn)一步進(jìn)展,才能釋放其潛力。
文章來源于悅智網(wǎng),作者Roel 、Joris
關(guān)鍵詞: 光芯片

EETOP 官方微信

創(chuàng)芯大講堂 在線教育

半導(dǎo)體創(chuàng)芯網(wǎng) 快訊
相關(guān)文章