日本科學(xué)家研發(fā)極簡(jiǎn)版EUV光刻技術(shù)!大幅降低成本及功耗!
2024-08-08 10:42:52 EETOP新系統(tǒng)在其光學(xué)投影設(shè)置中僅使用兩個(gè)反射鏡,這與傳統(tǒng)的六反射鏡配置有很大不同。這種光學(xué)系統(tǒng)的挑戰(zhàn)在于,需要將這些反射鏡排成一條直線,以確保系統(tǒng)在不產(chǎn)生通常與EUV光相關(guān)的畸變的情況下,保持高光學(xué)性能。與六反射鏡標(biāo)準(zhǔn)設(shè)置中只有約1%的初始EUV能量能到達(dá)晶圓相比,新的光路允許超過(guò)10%的初始EUV能量到達(dá)晶圓,這一改進(jìn)是一個(gè)重大突破。
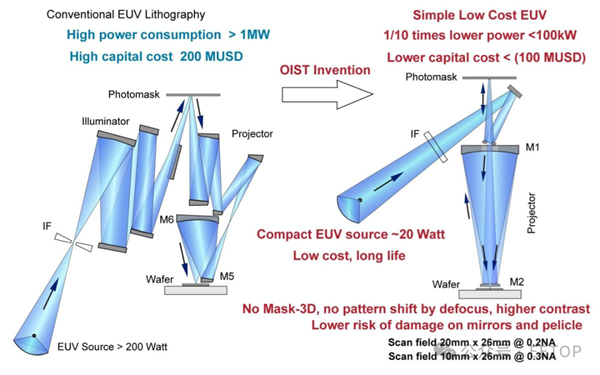
津森誠(chéng)教授的團(tuán)隊(duì)解決了EUV光刻中的兩大挑戰(zhàn):防止光學(xué)畸變和確保光的有效傳輸。OIST的“雙線場(chǎng)”方法能夠在不干擾光路的情況下照亮光罩,從而最大限度地減少畸變,并提高硅晶圓上的圖像精度。
這種極簡(jiǎn)設(shè)計(jì)的一個(gè)關(guān)鍵優(yōu)點(diǎn)是,它提高了可靠性并降低了維護(hù)的復(fù)雜性。這種 EUV 光刻工具設(shè)計(jì)的另一個(gè)優(yōu)點(diǎn)是大幅降低了功耗。由于優(yōu)化了光路,該系統(tǒng)僅需20W的EUV光源即可運(yùn)行,總功耗低于100kW。相比之下,傳統(tǒng)的EUV光刻系統(tǒng)通常需要超過(guò)1000KW的功率。由于功耗較低,新的光刻系統(tǒng)不需要復(fù)雜且昂貴的冷卻系統(tǒng)。

該新系統(tǒng)的性能已經(jīng)通過(guò)光學(xué)模擬軟件進(jìn)行了嚴(yán)格的驗(yàn)證,證實(shí)了其生產(chǎn)先進(jìn)半導(dǎo)體的能力。該技術(shù)的潛力已促使OIST申請(qǐng)專利,表明其已準(zhǔn)備好進(jìn)行商業(yè)化部署。
OIST致力于進(jìn)一步推進(jìn)其EUV工具設(shè)計(jì),以期實(shí)現(xiàn)實(shí)際應(yīng)用。該研究院認(rèn)為,這項(xiàng)創(chuàng)新是解決全球挑戰(zhàn)的重要一步,例如影響環(huán)境的芯片生產(chǎn)成本和半導(dǎo)體晶圓廠的功耗。
這項(xiàng)發(fā)明的經(jīng)濟(jì)影響前景廣闊。預(yù)計(jì)全球EUV光刻市場(chǎng)將從2024年的89億美元增長(zhǎng)到2030年的174億美元。隨著EUV工具設(shè)計(jì)的簡(jiǎn)化,未來(lái)幾年該行業(yè)可能會(huì)采用更多的EUV系統(tǒng)。然而,目前尚不清楚OIST距離其工具的商業(yè)化還有多遠(yuǎn)。
關(guān)鍵詞: EUV光刻機(jī) ASML EUV 光刻機(jī)

EETOP 官方微信

創(chuàng)芯大講堂 在線教育

半導(dǎo)體創(chuàng)芯網(wǎng) 快訊
相關(guān)文章