初創公司推出高性能符合UCIe標準的5納米小芯片互連技術,成功流片
2022-11-09 11:37:56 EETOP抓住這一勢頭,來自美國的初創公司Eliyan現在正在發力,帶來了一些令人興奮的技術。近日,Eliyan宣布了一輪成功的融資,推出了其高性能符合UCIe標準的5納米工藝芯片到芯片互連技術,并成功流片。
RFHoCKdDSDM7ic2icZPKQ/640?wx_fmt=png" data-type="png" data-w="865" data-index="1" data-origin-display="" _width="677px" crossorigin="anonymous" alt="圖片" src="http://www.xebio.com.cn/uploadfile/2022/1109/20221109113906630.jpg" data-fail="0" style="margin: 0px; padding: 0px; outline: 0px; max-width: 100%; box-sizing: border-box !important; overflow-wrap: break-word !important; vertical-align: bottom; height: auto !important; display: initial; visibility: visible !important; width: 677px !important;"/>

Eliyan創始人 - Syrus Ziai, Ramin Farjadrad, Patrick Soheili
當今計算行業最強大的趨勢之一是轉向基于小芯片的設計。
為了尋求更高性能的計算,片上系統 (SoC) 已成為最受歡迎的計算平臺之一。SoC背后的想法是創建一個異構系統,將盡可能多的計算功能集成到一塊硅片中。
然而,隨著SoC尺寸的不斷增長,它們正在接近芯片標線極限,這是在制造過程中可以暴露在單個光掩模下的最大芯片面積。
對此的解決方案是引入小芯片,由共享單個封裝并通過某個接口連接在一起的單個硅組成。“小芯片時代意味著你從一個尺寸有限的SoC開始,你打破每個功能來分離小芯片,然后將它們連接在一起。”公司聯合創始人Farjadrad說。“通過這種方式,你就不會有單個芯片太大而無法制造的問題。
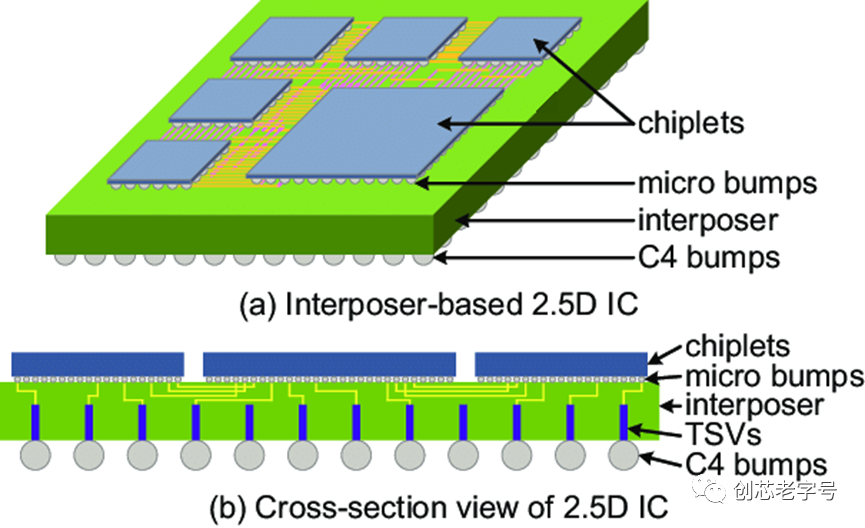
最近,小芯片之間使用的主要接口技術是硅中介層,它是一種硅襯底,在每個芯片之間提供高帶寬互連。然而,這種技術遠非完美。
“硅中介層是當今小芯片集成的主要方式,但它有許多缺點。” 公司聯合創始人Soheili說。“具體來說,它們仍然受到尺寸的限制,不能制造得太大。此外,為了連接到硅中介層,芯片設計有微凸塊。在作為該封裝的一部分集成之前,這些微凸塊無法在更安全的水平上進行全面測試,這將成為良率問題。此外,散熱因素會限制時鐘速率,并最終限制性能。
與傳統的硅中介層技術不同,Eliyan現在正在通過兩種獨特的小芯片技術擺脫隱身模式。
他們的第一個技術稱為NuLink,是一種用于小芯片的高性能芯片到芯片PHY解決方案。利用Farjadrad的Bunch of Wires(BoW)方案的概念,該方案已被開放計算項目(OCP)采用,NuLink的技術是UCIe / BoW的向后兼容超集,旨在實現先進的封裝,而沒有硅中介層的缺點,Farjadrad說。
“NuLink 是一種高性能解決方案,可提供與硅中介層相似的帶寬、功耗和延遲,但它允許您使用有機封裝。”
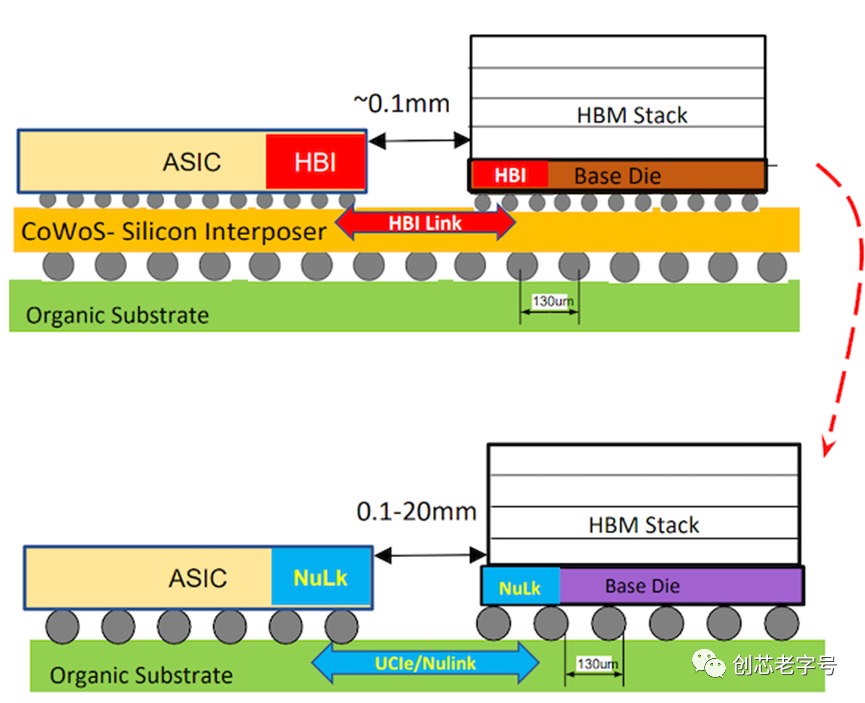 NuLink可以直接使用有機基質。圖片由Eliyan提供
NuLink可以直接使用有機基質。圖片由Eliyan提供盡管這可能很好,但仍然存在一個主要挑戰,即在慢速內存進程中實現高速 PHY 并不是很實用。為了解決這個問題,Eliyan推出了第二項技術,即NuGear 2.5/3D拓撲。
NuGear是一種拓撲結構,可用作適配器,在具有標準凸塊的有機基板上連接帶有微凸塊的現成小芯片。該方案提供 2.5D 和 3D 拓撲結構,最終無需修改高內存帶寬 (HMB) 基芯片即可消除對硅中介層的需求。
“基本上,如果你神奇地將NuGear放在兩側,你就會突然得到一個解決方案,它提供了高帶寬芯片到芯片PHY的所有優點,而沒有傳統的缺點。” Ziai說。
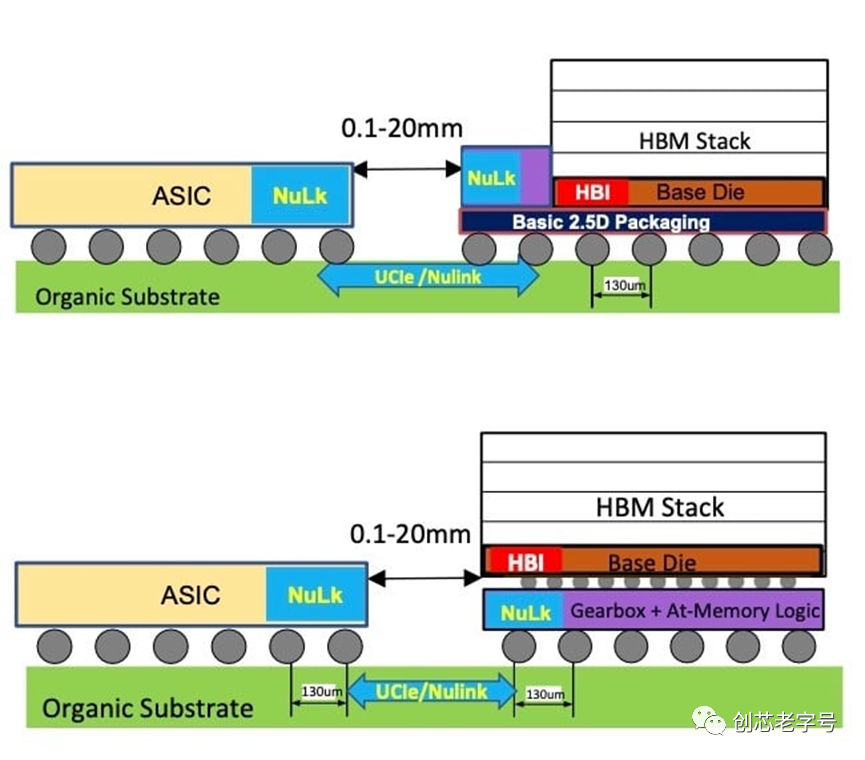 NuLink與NuGear一起顯示。NuGear(以前稱為Gearbox)可以提供2.5D(上圖)和3D(下圖)拓撲結構。圖片由Eliyan提供
NuLink與NuGear一起顯示。NuGear(以前稱為Gearbox)可以提供2.5D(上圖)和3D(下圖)拓撲結構。圖片由Eliyan提供
據該公司稱,NuLink 和 NuGear 的結合可實現更大的系統級封裝,每個封裝的 HBM 增加 4 倍,時鐘速率提高 20%,最終導致性能提高 10 倍。每個封裝更多的 HBM 也消除了對高功耗 ASIC 的需求,從而在相同的性能下節省大約 5 倍的功耗。
為了證明Eliyan技術的可行性,該公司今天發布了兩個重要的公告。
首先,他們已經正式完成了A輪融資,融資額為4000萬美元。其次,他們宣布在行業標準的納米工藝上成功流片他們的技術。
有了新的現金,該公司計劃加大研發力度,并推動其產品的商業準備。根據Eliyan的說法,該公司的第一批芯片預計將在2023年第一季度推出。