什么是CoWoS?用最簡單的方式帶你了解半導體先進封裝!
2023-08-09 12:43:08 technews(臺) 作者:許庭睿過去數(shù)十年來,為了擴增芯片的晶體管數(shù)量以推升運算效能,半導體制造技術已從1971 年10,000nm制程進步至2022年3nm 制程,逐漸逼近目前已知的物理極限,但隨著人工智能、AIGC等相關應用高速發(fā)展,設備端對于核心芯片的效能需求將越來越高;在制程技術提升可能遭遇瓶頸,但是運算資源需求持續(xù)走高的情況下,透過先進封裝技術提升芯片之晶體管數(shù)量就顯得格外重要。

什么是CoWoS?
CoWoS 是一種2.5D、3D 的封裝技術,可以分成CoW和WoS來看。CoW(Chip-on-Wafer)是芯片堆疊;WoS(Wafer-on-Substrate)則是將芯片堆疊在基板上。CoWoS 就是把芯片堆疊起來,再封裝于基板上,最終形成2.5D、3D 的型態(tài),可以減少芯片的空間,同時還減少功耗和成本。下圖為CoWoS 封裝示意圖,將邏輯芯片及HBM(高帶寬存儲器)先連接于中介板上,透過中介板內微小金屬線來整合左右不同芯片的電子信號,同時經由砂穿孔(TSV)技術來連結下方基板,最終透過金屬球銜接至外部電路。

而2.5D 與3D 封裝技術則是差別在堆疊方式。2.5D 封裝是指將芯片堆疊于中介層之上或透過硅橋連結芯片,以水平堆疊的方式,主要應用于拼接邏輯運算芯片和HBM;3D 封裝則是垂直堆疊芯片的技術,主要面向高效能邏輯芯片、SoC 制造。
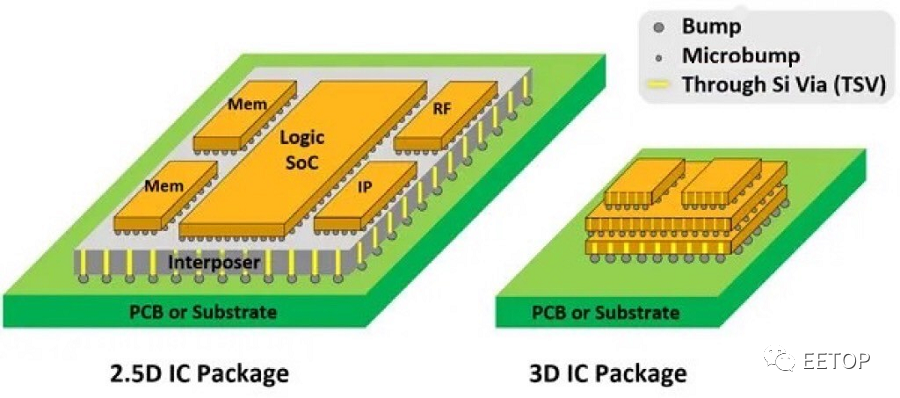
先進封裝,但不在封裝廠完成!
CoWoS的應用發(fā)展
高階芯片走向多個小芯片、存儲器,堆疊成為必然發(fā)展趨勢,CoWoS 封裝技術應用的領域廣泛,包含高效能運算HPC、AI 人工智能、數(shù)據(jù)中心、5G、物聯(lián)網、車用電子等等,可以說在未來的各大趨勢,CoWoS 封裝技術會扮演著相當重要的地位。
過去的芯片效能都仰賴半導體制程的改進而提升,但隨著元件尺寸越來越接近物理極限,芯片微縮難度越來越高,要保持小體積、高效能的芯片設計,半導體產業(yè)不僅持續(xù)發(fā)展先進制程,同時也朝芯片架構著手改進,讓芯片從原先的單層,轉向多層堆疊。也因如此,先進封裝也成為延續(xù)摩爾定律的關鍵推手之一,在半導體產業(yè)中引領浪潮。

EETOP 官方微信

創(chuàng)芯大講堂 在線教育

半導體創(chuàng)芯網 快訊
相關文章