臺積電推出支持5nm制程的最新CoWoS封裝技術
2020-03-04 12:23:59 EETOP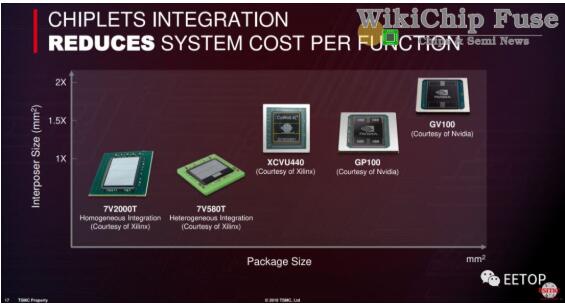
CoWoS全稱為Chip-on-Wafer-on-Substrate,是臺積電晶圓級系統整合組合(WLSI)的解決方案之一。
臺積電和博通將支援業界首創且最大的兩倍光罩尺寸(2X reticle size)之中介層,面積約1,700平方毫米。此項新世代CoWoS中介層由兩張全幅光罩拼接構成,能夠大幅提升運算能力,借由更多的系統單晶片來支援先進的高效能運算系統,并且也準備就緒以支持臺積電下一世代的5nm制程技術。
臺積電表示,此項新世代CoWoS技術能夠容納多個邏輯系統單晶片(SoC)、以及多達六個高頻寬存儲器(HBM)立方體,提供高達96GB的存儲容量;此外,此技術提供每秒高達2.7兆位元的頻寬,相較于臺積電2016年推出的CoWoS解決方案,速度增快2.7倍。
CoWoS解決方案具備支援更高存儲容量與頻寬的優勢,非常適用于存儲密集型之處理工作,例如深度學習、5G網絡、具有節能效益的數據中心、以及其他更多應用。除了提供更多的空間來提升運算能力、輸入/輸出、以及HBM整合,強化版的CoWoS技術也提供更大的設計靈活性及更好的良率,支援先進制程上的復雜特殊應用晶片設計。
在臺積電與博通公司合作的CoWoS平臺之中,博通定義了復雜的上層晶片、中介層、以及HBM結構,臺積電則是開發生產制程來充分提升良率與效能,以滿足兩倍光罩尺寸中介層帶來的特有挑戰。透過數個世代以來開發CoWoS平臺的經驗,臺積電開發出獨特的光罩接合制程,能夠將CoWoS平臺擴充超過單一光罩尺寸的整合面積,并將此強化的成果導入量產。
CoWoS能夠與電晶體微縮互補且在電晶體微縮之外進行系統級微縮。除了CoWoS之外,臺積電三維集成電路技術平臺,例如整合型扇出(InFO)及系統整合晶片(SoIC),透過小晶片分割與系統整合來實現創新,達到更強大的功能與強化的系統效能。
免責聲明:本文由作者原創。文章內容系作者個人觀點,轉載目的在于傳遞更多信息,并不代表EETOP贊同其觀點和對其真實性負責。如涉及作品內容、版權和其它問題,請及時聯系我們,我們將在第一時間刪除!
