領(lǐng)先臺積電一年,三星發(fā)布3nm GAA工藝 PDK ! 明年可流片,全面超越FinFET
2019-05-15 12:22:31 EETOP而根據(jù)國際商業(yè)戰(zhàn)略咨詢公司(International Business Strategies) 執(zhí)行長Handel Jones 表示,目前三星正透過強(qiáng)大的材料研究讓晶圓制造技術(shù)獲得發(fā)展。而在GAA 的技術(shù)發(fā)展上,三星大約領(lǐng)先臺積電1 年的時(shí)間,而英特爾封面則是落后三星2 到3 年。
與7nm技術(shù)相比,三星的3GAE工藝可將芯片面積減少45%,功耗降低50%或性能提高35%。基于GAA的工藝節(jié)點(diǎn)有望在下一代應(yīng)用中廣泛采用,例如移動,網(wǎng)絡(luò),汽車,人工智能(AI)和物聯(lián)網(wǎng)。
三星計(jì)劃通過其3納米工藝的專有MBCFET™(多橋通道FET)技術(shù)為其無晶圓廠客戶提供獨(dú)特的優(yōu)勢。MBCFET™是一種先進(jìn)的薄而長的線型GAA結(jié)構(gòu),可堆疊薄而長的納米片,如紙張,以提高性能和功率效率,以及與pinpet工藝的兼容性。它具有利用技術(shù)的優(yōu)勢。
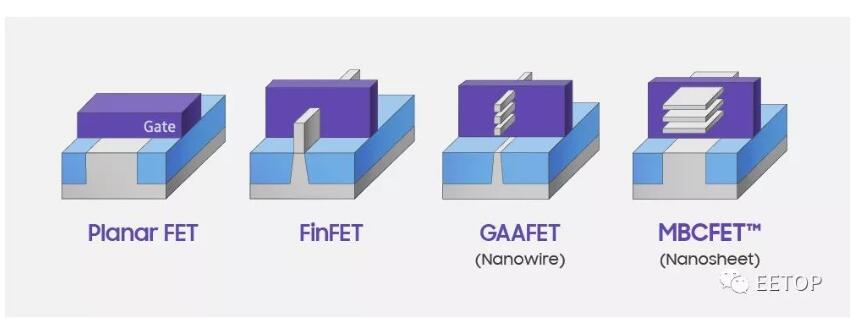
平面FET,F(xiàn)inFET,GAAFET,MBCFET™晶體管結(jié)構(gòu)
超越FinFET:GAA
在過去十年中,基于邏輯的工藝技術(shù)創(chuàng)新的主要驅(qū)動力是FinFET。與標(biāo)準(zhǔn)平面晶體管相比,F(xiàn)inFET在工藝節(jié)點(diǎn)減小時(shí)允許更好的性能和電壓縮放,從而最大限度地減少了晶體管限制的負(fù)面影響。FinFET通過在垂直方向上縮放來增加晶體管的溝道和柵極之間的接觸面積,與平面設(shè)計(jì)相比允許更快的切換時(shí)間和更高的電流密度。
然而,就像平面晶體管一樣,F(xiàn)inFET晶體管最終會達(dá)到一個(gè)極限點(diǎn),隨著工藝節(jié)點(diǎn)的收縮,它們無法伸縮。為了擴(kuò)大規(guī)模,通道和柵極之間的接觸面積需要增加,實(shí)現(xiàn)這一點(diǎn)的方法是采用Gate-All-Around(GAA)的設(shè)計(jì)。GAA調(diào)整晶體管的尺寸,以確保柵極不僅在頂部和兩側(cè),也在通道下方。這使得GAA設(shè)計(jì)可以垂直堆疊晶體管,而不是橫向堆疊。

基于GAA的FET(GAAFET)可以具有多種形狀因子。大多數(shù)研究都指向基于納米線的GAAFET,具有較小的通道寬度并使通道盡可能小。這些類型的GAAFET通常可用于低功耗設(shè)計(jì),但難以制造。另一種實(shí)現(xiàn)方式是使通道像水平板一樣,增加通道的體積,從而提供性能和擴(kuò)展的好處。這種基于納米片的GAAFET是三星所謂的多橋通道FET或MBCFET,它將成為該公司的商標(biāo)名稱。
在平面晶體管縮放到22nm/ 16nm左右的情況下,當(dāng)我們從22nm/ 14nm下降到5nm和4nm時(shí),F(xiàn)inFET是理想的。三星計(jì)劃在其3nm設(shè)計(jì)上推出基于納米片的GAAFET,完全取代FinFET。
當(dāng)半導(dǎo)體公司在給定工藝上設(shè)計(jì)新芯片時(shí),他們需要的工具之一是來自代工廠的設(shè)計(jì)套件(PDK)。例如,對于在14nm芯片上創(chuàng)建Arm芯片的人來說,他們會調(diào)用Arm并要求為三星、臺積電或GlobalFoundries提供的Cortex-A55設(shè)計(jì)套件,該套件已針對該流程進(jìn)行了優(yōu)化。對于14nm,這些設(shè)計(jì)套件非常成熟,根據(jù)您是否需要高頻率或低功耗優(yōu)化,Arm可能會提供不同的版本。
然而,對于一個(gè)新的工藝技術(shù)時(shí),PDK會經(jīng)歷alpha和beta版本。PDK包含流程的設(shè)計(jì)規(guī)則,以及用于實(shí)現(xiàn)功耗和性能最佳的優(yōu)化。
三星在今天推出其第一代3nm alpha版PDK,用于采用MBCFET的第一代3nm工藝。三星將此流程稱為“3GAE”流程,這個(gè)alpha版本將允許其合作伙伴開始掌握其3GAE流程的一些新設(shè)計(jì)規(guī)則。
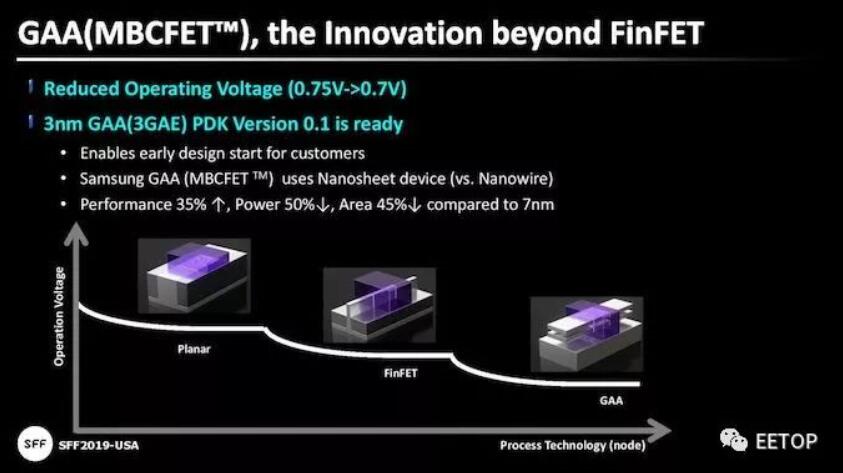
三星在其首個(gè)3GAE流程中做出了許多承諾。其中一個(gè)標(biāo)題是將工作電壓從0.75伏降低到0.70伏。與7nm相比,三星的3GAE工藝旨在將芯片面積減少45%,功耗降低50%或性能提高35%。
三星表示,這些性能數(shù)據(jù)基于對頻率很重要的關(guān)鍵路徑使用較大寬度的單元,而對于非關(guān)鍵路徑使用較小寬度單元,其中節(jié)能是至關(guān)重要的。
從中可以看出其中的一些:三星預(yù)計(jì)其3GAE流程將在2020年首次提供客戶流片,2020年末風(fēng)險(xiǎn)生產(chǎn),2021年末批量生產(chǎn)。
除了3GAE之外,三星已經(jīng)預(yù)測其第二代3nm工藝將被稱為3GAP,重點(diǎn)是高性能操作。3GAE將于2021年投入風(fēng)險(xiǎn)生產(chǎn),大規(guī)模生產(chǎn)可能在2022年。
PDK工具包括SPICE,DRC,LVS,PEX,P-Cell,F(xiàn)ill Deck和P&RTechfile。EDA合作伙伴包括Cadence,Mentor和Synopsis。(整理自:anandtech、三星官網(wǎng)、technews)

EETOP 官方微信

創(chuàng)芯大講堂 在線教育

半導(dǎo)體創(chuàng)芯網(wǎng) 快訊
相關(guān)文章