根據(jù)外媒報道,在上周的HotChips 34 大會上,英特爾CEO 帕特·基爾辛格(Pat Gelsinger)闡述了英特爾對未來的愿景,而這一愿景的基礎在于結合多個小芯片設計的先進封裝。這在業(yè)界來說并不是什么新鮮事,但卻說明了英特爾對即將推出的以小芯片設計的代號Meteor Lake 系列CPU 的重視。而且,Pat Gelsinger 還說明了這基礎如何影響未來整個半導體產(chǎn)業(yè)。Pat Gelsinger 表示,小芯片設計將先進封裝將延續(xù)未來10 年摩爾定律的蓬勃發(fā)展。甚至,到2030 年之際,晶體管密度將增加10 倍,這將使得英特爾在芯片上發(fā)展到擁有1 萬億個晶體管。Pat Gelsinger 表示,小芯片加先進封裝對半導體產(chǎn)業(yè)最大的變化是擺脫了晶圓廠只生產(chǎn)晶圓的觀念。相反,他認為這項服務正在演變成為客戶提供完整的「系統(tǒng)」。該系統(tǒng)包括提供晶圓以及多個小芯片、先進的封裝,以及將它們連接在一起的軟體。這樣的做法稱之為System on Package,簡稱SOP。Pat Gelsinger 解釋,數(shù)據(jù)中心內的機架式服務器蔚為風尚,這就是依賴以SOP 為主所累積起來的發(fā)展模式,也就是當SOP 成為了先進系統(tǒng)后,未來就能看到整體的持續(xù)發(fā)展。

事實上,要達到這種改變,其中一部分涉及節(jié)點微縮以及芯片堆疊技術。英特爾之前已經(jīng)討論過,將在2024年將放棄FinFET 技術,轉而使用環(huán)柵(GAA) RibbonFET技術,也就是將在其intel 20A 節(jié)點的解點開始采用新的技術。同時,還將以PowerVIA,也就是背面供電技術來支援。Pat Gelsinger 認為,這種制程以及封裝技術的進步,將為半導體提供無限制的進步。「今天,一個芯片上大約有1,000 億個晶體管。而在有了環(huán)柵(GAA) RibbonFET 技術之后,將會產(chǎn)生一個芯片新的基本晶體管結構,預計到達2030 年之際,將可以使得晶體管數(shù)量達到1 萬億個,而英特爾也會持續(xù)發(fā)展。」Pat Gelsinger 說道。

Pat Gelsinger 強調,下一代代號Meteor Lake 系列CPU采小芯片及先進封技術是一種未來。這代表著根據(jù)最有效的方式組合不同的小芯片,而每個小芯片依需求構建在不同的制程節(jié)點上。例如,Meteor Lake 系列CPU 將結合自己的代工廠和臺積電的四個不同制程節(jié)點。它將在其22 納米制程上構建基礎中介層,并在Intel 4 (之前為7 納米) 上構建CPU 小芯片。同時,臺積電將采用的5 納米和6 納米制程來生產(chǎn)SoC、I/O 和GPU 等的小芯片。而從這些不同制程所生產(chǎn)出來的各個小芯片,英特爾再將其以先進封裝技術整合連結再一起,最后生產(chǎn)出了Meteor Lake 系列CPU。報道進一步指出,隨著芯片縮小未來變得不那么頻繁,并且小芯片生產(chǎn)將會是其中的關鍵下,這些小芯片與元器件如何整合在一起將成為未來幾年的關鍵技術。為此,Pat Gelsinger 還推薦了基于PCI Express 的通用小芯片連接器。這個由英特爾所主導,包括AMD 和高通等相關知名半導體廠商也參與的Universal Chiplet Interconnect Express (UCIe) 聯(lián)盟所開發(fā)出來的標準,目的在標準化來自不同代工廠的小芯片的連結和協(xié)同工作。而這聯(lián)盟未來值得關注的,就是蘋果和英偉達兩家廠商是不是也會加入。
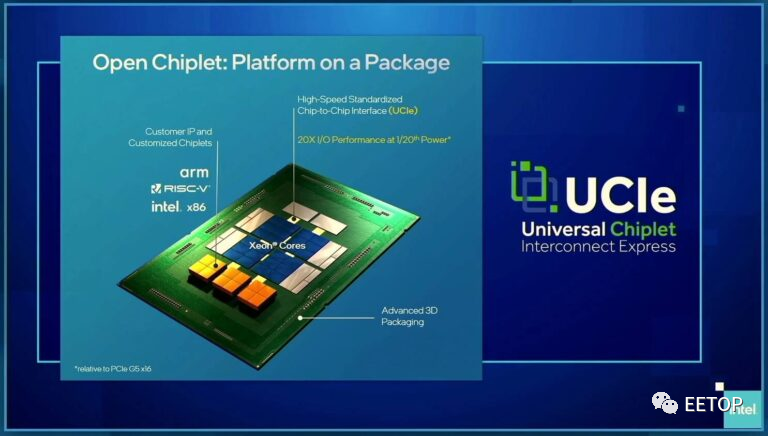
不過,市場人士指出,這是否會成為英特爾的致勝戰(zhàn)略還有待觀察,但是應該很快就能看到答案。因為英特爾會議上確認代號Meteor Lake 系列CPU 將在2023年的推出。這將是該公司采小芯片設計的重要產(chǎn)品,具有來自兩個不同代工廠所生產(chǎn)出來的小芯片,能不能受到市場青睞至關重要。另外,先前市場傳出Meteor Lake 系列CPU 就是因為大小芯片設計的連結與協(xié)同運作設計有其問題,因此將延后推出的情況。不過,對此英特爾否認了傳聞,并指出計劃仍按照時程進行中。