芯片巨頭的垂直革命!英特爾、臺積電、三星 3D IC 技術大比拼
2025-05-12 13:25:29 EETOP英特爾代工(Intel Foundry)、臺積電(TSMC)和三星代工(Samsung Foundry)都在爭相提供全3D-IC(三維集成電路)的所有基礎組件。在未來幾年內,這些組件共同作用,將以最小的功耗實現性能數量級的提升。
目前,人們對工藝節點的進步投入了大量關注,但成功實現3D-IC的實施要比單純縮放數字邏輯復雜和全面得多。這需要新材料,以及處理更薄基板并將它們組合在一起的不同方法。它涉及不同的背面供電方案、各種類型的橋接、多芯片通信的接口標準,以及新的互連技術和方法。而且這將需要對電子設計自動化(EDA)工具和方法、數字孿生、多物理場模擬進行重大變革,同時還需要對工程團隊和流程進行重組,并在從設計到制造的各個階段注入人工智能。
3D-IC在代工廠的內部路線圖上已經存在了十多年,但直到兩年前 ChatGPT 的推出以及隨后人工智能數據中心的建設,全芯片堆疊才真正獲得了發展動力。從那時起,重點一直放在大幅提升功耗和性能上,而實現這一目標的最佳途徑是分解片上系統(SoC),將大量計算元件并行化,并減少信號在不同處理元件和存儲器之間來回穿梭時遇到的距離、電阻和電容。
垂直集成的優勢
這里的目標大家都很清楚,但實現這些目標所需的一些技術仍在開發中。這就解釋了為什么所有代工廠都宣布計劃在未來幾年內各自投入約 1000 億美元,以實現3D-IC的批量生產。有很多問題需要解決,而且其中大多數問題需要預先解決并在硅片上得到驗證,以使這項工作取得成功。從技術和經濟的角度來看,僅僅依靠平面縮放帶來的功耗、性能和面積 / 成本優勢已經不夠了。
臺積電業務發展和全球銷售高級副總裁張曉強(Kevin Zhang)表示:“晶體管技術和先進封裝集成必須攜手共進,才能為我們的客戶提供完整的產品級解決方案。三維架構技術組合對我們來說已經變得非常重要。”
有充分的記錄表明,在平面片上系統中,信號的傳輸速度比在某種類型的系統級封裝中的不同芯片之間要快。但是,雖然數字晶體管仍在不斷縮放,靜態隨機存取存儲器(SRAM)和導線卻并非如此。在最先進的節點上,將所有東西都封裝在單個光罩尺寸的芯片上常常會導致良率低下,并且首次流片成功的概率大幅下降。
作為回應,系統公司和領先的處理器供應商已經開始分解片上系統,并將它們轉變為先進封裝中的小芯片組件。小芯片的良率比大型片上系統更高,而且每個小芯片的設計成本更低。從理論上講,將多少小芯片組裝成定制封裝以提高性能是沒有限制的。
然而,當數據需要在存儲器和處理元件之間來回移動時,這些多芯片組件的性能會急劇下降。這就是所謂的存儲墻,它是距離和信號在導線上傳播速度的函數。高帶寬存儲器(HBM)對于三級緩存來說效果很好。由于其更寬的通道(HBM4 有 2048 條通道),它比標準動態隨機存取存儲器(DRAM)快得多,這有助于降低電阻和電容。但靜態隨機存取存儲器仍然更快,使其成為一級和二級緩存的首選存儲器。靜態隨機存取存儲器通常配置有六個晶體管,與使用一個晶體管和一個電容的動態隨機存取存儲器相比,它顯著提高了訪問速度。需要這個電容來解決電荷泄漏問題,當動態隨機存取存儲器發熱時有時會自發發生電荷泄漏。
混合方法會有所幫助,堆疊更多層的高帶寬存儲器也是如此。三星、SK 海力士和美光(Micron)是僅有的生產高帶寬存儲器的公司。三星已將其作為一個跳板,開始針對特定的工作負載定制高帶寬存儲器。但最佳解決方案是同時使用更多的高帶寬存儲器和靜態隨機存取存儲器,代工廠的最新路線圖顯示,不同存儲器的復雜組合采用了非常緊密的互連間距,以促進數據移動。
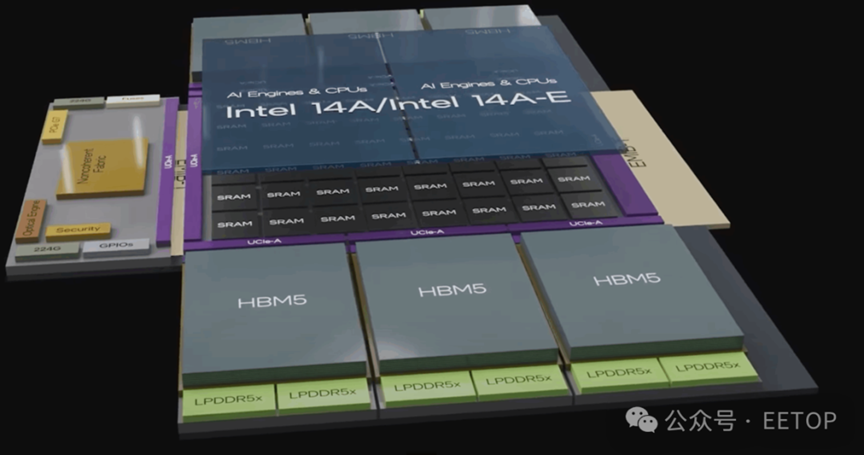
圖 1:英特爾的 3D-IC 概念,將 14A 小芯片封裝在 SRAM 之上,采用 EMIB 橋接技術將其連接到 I/O,并被 HBM 包圍以實現 L3 緩存。
英特爾的最新架構顯示,14A 邏輯層直接堆疊在靜態隨機存取存儲器模塊層之上。
英特爾代工高級副總裁兼總經理 Kevin O’Buckley 表示:“每個人都在談論存儲墻。隨著我們不斷縮放更多的核心,并將計算性能提升得越來越高,滿足數據需求成為了首要任務。3D-IC是我們可以將芯片面積的很大一部分用于靜態隨機存取存儲器,同時又不犧牲所需計算面積的一個例子。”
不過,這種方法需要一種完全不同的芯片組裝方式。邏輯層堆疊邏輯層也是如此,這種方式已經在規劃階段存在了多年,但由于散熱問題在很大程度上被擱置。這里的目標是通過添加另一層處理元件和存儲器,將晶體管密度提高一倍,并使它們表現得像一個單一系統。
臺積電張曉強表示:“我們從面到背的集成開始,將兩個芯片組合在一起。我們也在開發面對面的集成方式,讓客戶能夠最大限度地提高兩個芯片之間的互連密度。如果你看一下我們將芯片堆疊在一起時的混合鍵合間距,它將從 9 微米繼續縮小到 6 微米,甚至可以低至 5 微米及以下。這種集成將包括面到背和面對面的方式,以滿足不同的應用需求。”
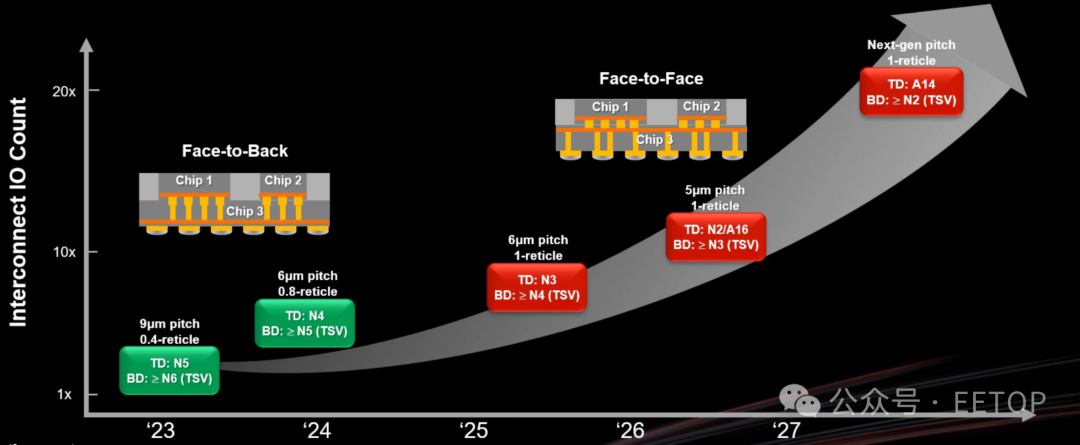
圖 2:臺積電的 3D-IC 路線圖顯示了不同的集成策略
去年春天的一次演示中,三星代工業務發展副總裁 Taejoong Song 展示了一個路線圖,其特點是將邏輯層堆疊在邏輯層上并安裝在基板上,將一個 2 納米(SF2)芯片堆疊在一個 4 納米(SF4X)芯片之上,兩者都安裝在另一個基板上。這基本上是一個 2.5D 封裝上的 3D-IC,有時也被稱為 3.5D。Song 表示,代工廠將從 2027 年開始在 SF2P 之上堆疊 SF1.4。
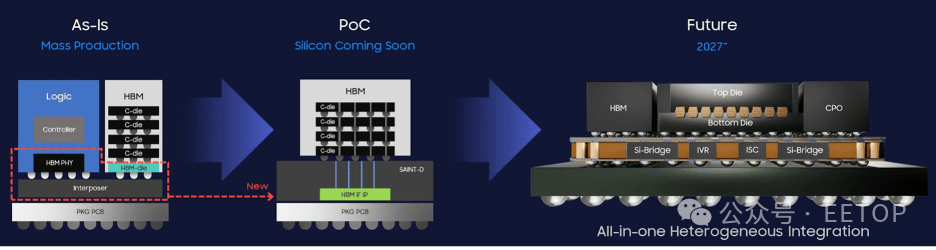
圖 3:三星的 3D-IC 路線圖

垂直集成的限制
無論布局如何,散熱仍然是最大的挑戰,這也是3D-IC進展緩慢的最常被提及的原因。從那時起,情況發生了很大變化,領先的芯片制造商對性能和功耗的要求需要齊心協力來解決這個問題。
雖然這項技術的確切交付日期仍然模糊,但這三家代工廠現在都在其路線圖上突出顯示了3D-IC。至少部分解決方案可能是將最新節點開發的邏輯與 N-1 或 N-2 節點的邏輯相結合。但目標是實現更緊密的集成,使其表現得像一個系統,并通過高速接口連接到從平面片上系統中剝離出來的其他關鍵組件。
在過去幾年中,已經出現了多種去除積聚熱量的解決方案,但并非所有解決方案都已準備好進行大規模生產。其中包括:
1.硅通孔(Thermal vias)。硅通孔可用于將熱量直接從處理元件引導到封裝外部的散熱器。這里的挑戰是確定這些微型 “煙囪” 的數量和位置,因為不同的工作負載會產生獨特的熱梯度。
2.蒸汽帽(Vapor caps)。這種方法的工作原理類似于蒸發式(又名沼澤式)冷卻器。當氣體經過濕墊時,它會吸收液體,然后蒸發,將一些熱量散發到外部散熱器。最初使用這種方法的實驗失敗了,因為目標設備是經常被移動和搖晃的移動電話。但在數據中心,服務器機架在使用時是固定的,這使得這種方法更可行且成本相對較低。
3.微流體技術(Microfluidics)。這個想法可以追溯到 20 世紀 80 年代,當時大型機需要水冷(現在對于某些系統來說,水冷再次成為一種選擇,盡管不一定是用水)。這使得升級變得困難,而且像所有的管道系統一樣,有時會漏水。當安裝了風冷的小型計算機和裝滿個人電腦服務器刀片的機架時,許多客戶認為這是一個巨大的優勢。但隨著晶體管密度的提高和繁重的工作負載,通過微小通道移動液體再次成為積極研究的方向。
4.熱界面材料(Thermal interface materials)。這些材料有墊片、膏狀和固體材料等形式(最近還有碳納米管),它們在傳導熱量方面很有效,但也很昂貴,而且長期來看相對未經測試。行業仍在努力確定使用哪些材料、以何種組合使用,以及在哪個階段可以實現規模經濟。
5.浸沒式冷卻(Immersion)。雖然這聽起來違反直覺,但電子產品可以浸沒在惰性液體中而不會導致短路。這里的挑戰是可重復使用性、可持續性和成本。
為數據設計
在多芯片組件中增加晶體管的數量也會增加布線的擁擠程度。先進的布局布線工具已經能夠實現大部分自動化,但它們無法解決為所有晶體管供電的問題,而這對于保持性能至關重要。這就是為什么這三大代工廠要么已經開發,要么正在開發背面供電(BPD)技術:
1.英特爾的 PowerVia 背面供電技術將在今年的 18A 節點中與帶狀場效應晶體管(RibbonFET)納米片晶體管一同推出;
2.臺積電將從 2026 年下半年開始,在 A16 節點引入超級電源軌背面供電技術;
3.三星將從 2027 年開始在 2 納米節點提供 SF2Z 背面供電技術。
將供電網絡移到芯片外部縮短了電力傳輸的距離,并且使得通過芯片中的各種金屬層布線信號變得更簡單。因此,與復雜的布線相比,現在的布線可以更加直接,特別是在充滿硅通孔并通過混合鍵合連接的芯片之間。
楷登電子(Cadence)高級產品總監 Mick Posner 表示:“你有能力在芯片之間擁有成千上萬的硅通孔。這很棒,但每個比特需要 0.003 皮焦耳的能量,雖然這個能量很小。然而,當你把它們全部塞進 1 平方毫米的區域時,能量需求就會累積起來。你需要進行熱點分析,并且管理這個功率范圍以及計算密集型芯片正在做的任何其他事情將是一個挑戰。功率密度已經會很高,而且我們已經看到熱膨脹會使一疊芯片分開。存在很多挑戰。但也有提升性能的能力。而且因為芯片在寬度上的擴展是有限的,所以現在必須在垂直方向上發展。那么為什么不構建一個‘摩天大樓’呢?”
這就是大致的想法。然而,要充分發揮芯片堆疊的優勢,這些層需要更薄,以減少信號傳輸的距離。此外,并非所有層都需要堆疊。例如,高帶寬存儲器可以設計成圍繞著3D-IC邏輯堆棧,并與輸入 / 輸出和其他存儲器進行高速連接。
為了真正加快這一進程,其中一些連接可能會采用光接口和共封裝光學技術。所有主要代工廠都在其路線圖中納入了共封裝光學技術,因為光能夠以極快的速度移動數據,同時產生更少的功耗和熱量積聚。
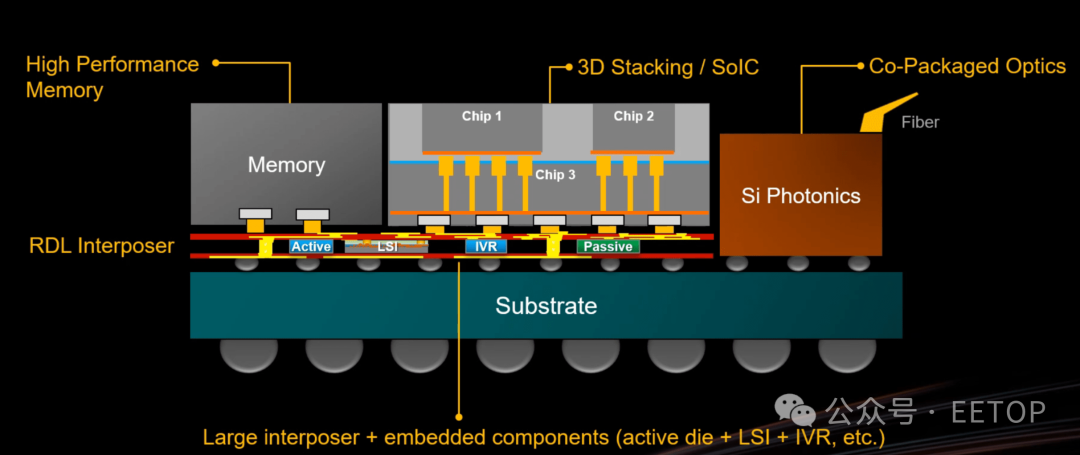
4:TSMC 計劃將共封裝光學器件與其 3D-IC 模型相結合
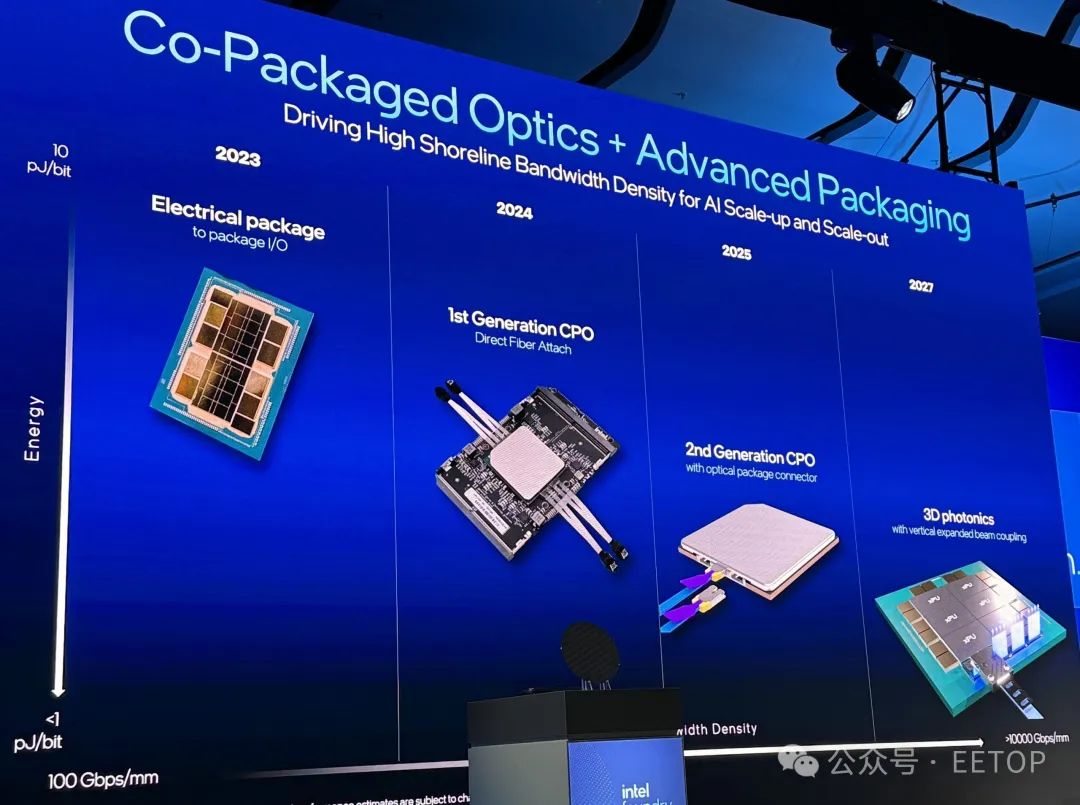
圖 5:Intel 的光學路線圖
英特爾代工的首席技術與運營官兼總經理 Naga Chandrasekaran 在最近的一次演示中表示:“光互連與傳統的電輸入 / 輸出相比具有顯著優勢。在提高邊緣密度方面,它在帶寬、延遲和功率效率方面都有好處。當我們能夠采用光互連并將其應用于芯片到芯片的層面,再結合英特爾的先進封裝能力時,這個解決方案將在我們如何擴展基于人工智能的解決方案方面提供顯著優勢。它將提供更密集和更先進的互連能力。此外,在計算領域,通過采用共封裝光學解決方案,我們可以實現更低的延遲和更高的吞吐量。”
與3D-IC中的大多數事情一樣,這說起來容易做起來難。一方面,光不會拐彎,所以波導不能有任何直角。它們還需要光滑,因為任何粗糙度都會產生與電互連中的線邊緣粗糙度相同的效果。除此之外,光會對熱產生反應,在不可預測的工作負載下,可能會導致光的偏移超出預期。
英特爾的 O’Buckley 表示:“現在計算系統的實際情況是,它不僅僅局限于一塊電路板。在大多數情況下,它甚至不局限于一個機架。如果你看看當今地球上一些最大的系統公司正在做的事情,比如超大規模數據中心或英偉達(NVIDIA)開發的人工智能系統,在提升性能指標方面,連接性與計算能力同樣重要。銅一直是我們行業幾代人的支柱,而光學則是連接城鎮的技術。現在,光學能夠使太比特級別的帶寬在機架之間連貫地傳輸,這一點至關重要。過去,連接通常發生在交換機層面。但由于這些系統對一致性和延遲的要求,我們現在討論的是直接將光學連接驅動到計算集群,而不是必須通過交換機。毫無疑問,這就是行業的發展方向。”
至少部分解決方案是智能地放置光學組件。O’Buckley 表示:“很多時候取決于激光源的位置。目前在光學領域的一些創新是,像復用(MUXing)這樣的元件往往對溫度不太敏感。你可以把它們放置得離計算元件很近。然后對于激光源和一些傳感設備,你可以把它們移得稍遠一點。以這種方式進行一些光學操作可以分離激光源,這也是一些公司正在選擇做的事情。”
臺積電的張曉強表示,光子學也可用于減少芯片中的熱量。“在不久的將來,我們將看到客戶使用集成硅光子學將信號引出以實現芯片到芯片的連接。我們都知道,在信號傳輸方面,光子比電子效率高得多。電子在計算方面非常出色,但在信號方面,光子更勝一籌。”
張曉強表示,另一個關鍵選擇是集成電壓調節器,這將進一步提高功率效率。“這非常重要,因為客戶或未來的人工智能產品希望將多個邏輯層和多個高帶寬存儲器集成在一起。這些都會消耗功率。如果你看看當今先進的人工智能加速器,我們說的功率輕松就能達到 1000 瓦。未來可能會達到幾千瓦。將電源引入這樣的封裝非常困難,所以通過使用集成電壓調節器,你可以降低電流需求,因為凸點的數量是有限的。你不能僅僅輸入那么多電流。”
這反過來又減少了封裝中的整體熱量。
工藝縮放
這可能有點違反直覺,但要最大限度地發揮3D-IC的性能優勢,需要持續的工藝縮放。原因與其說是晶體管的性能(盡管芯片制造商肯定可以充分利用這一點),不如說是動態功率密度。更小的晶體管功率效率更高,這有助于在大型數據中心減少熱量并降低能源成本。此外,從鰭式場效應晶體管(finFET)向環繞柵極場效應晶體管(gate-all-around FET)的轉變減少了靜態泄漏,靜態泄漏也會產生熱量并積聚在封裝中。
以臺積電即將推出的 A14 節點為例,這是繼 2 納米之后的下一個完整節點。張曉強表示:“與上一代相比,A14 節點的縮放優勢非常顯著。它的速度提升高達 15%,功耗降低 30%,邏輯密度提高 1.23 倍。總體芯片密度至少提高 1.2 倍,所以這是一項非常非常重要的技術。這項技術還具有 NanoFlex Pro 技術。這實際上是設計技術協同優化的結果,使設計師能夠以非常靈活的方式設計他們的產品,以實現最佳的功率和性能優勢。這項技術將在 2028 年投入生產。”
張曉強指出,該節點的第一個版本將不包括背面供電技術,背面供電技術要到 2029 年的第二個 A14 版本才會添加。

圖 6:TSMC 的工藝路線圖
intel 的 RibbonFET 是 GAA FET 的代工廠名稱,其中包括一些“色帶”的定制選項。
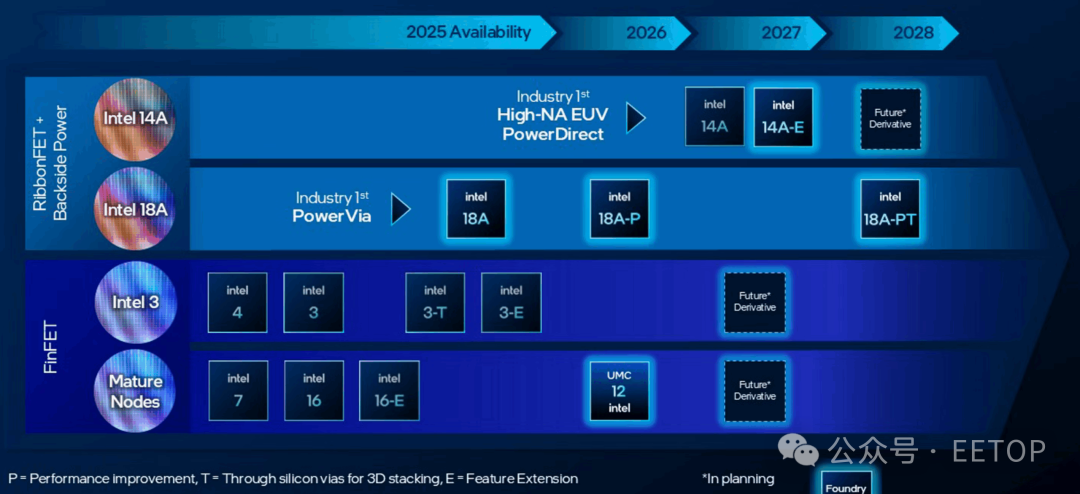 圖 7:Intel 的流程路線圖
圖 7:Intel 的流程路線圖
與此同時,三星在 2nm 節點推出了其 GAA 技術。

圖 8: Samsung 的流程路線圖
未來應用
3D-IC的初始應用將在人工智能數據中心內,但一旦工藝得到鞏固并且解決了各種問題,這種方法可以更廣泛地應用,并且可以采用更有針對性的組件組合。是否所有應用都需要完整的3D-IC,或者只需要這些技術的一些核心部分,仍有待確定。盡管如此,在堆疊芯片中解決的技術問題將有廣泛的應用。
張曉強表示:“我們認為移動領域有很多創新空間。我們認為增強現實眼鏡是一個未來的業務增長機會。這些眼鏡是透明的,外形小巧,而且可以整天佩戴。為了實現一整天的電池續航,具備強大的計算能力,你真的需要先進的硅芯片。你需要很多傳感設備。你需要連接性,所以需要大量的硅含量。”
他說,人形機器人也是如此。“汽車行業希望實現自動駕駛。你可以把汽車看作是構建機器人的第一步。汽車是一種簡單的機器人。它只是把你從 A 點帶到 B 點。但在未來,如果你真的想要一個能與人互動并幫助你處理很多人類不想做的事情的機器人,你需要構建這些所謂的人形機器人。如果你深入研究這些機器人,你會看到大量的硅芯片。首先,你需要具備智能。你需要有良好的人工智能能力。你需要先進的硅芯片來為智能提供動力。你還需要有良好的傳感能力和良好的功率輸出能力。而且你需要很多集成控制器,以便在不同條件下發揮功能。”
結論
不同的代工廠在開發3D-IC所需的所有必要組件方面處于不同的階段。沒有一家代工廠能夠一次性解決所有這些問題,而且如今芯片行業的容錯率相對較高。由于供應鏈中持續存在的地緣政治干擾,芯片制造商正在尋找多個來源和多種技術選擇。
西門子 EDA 首席執行官 Mike Ellow 表示:“我們同時面臨著挑戰、機遇和困境。我們如何讓初級工程師和職業工程師能夠應對他們必須交付的大量新設計,并為這些設計提供硅芯片呢?世界依賴于一個有彈性、強大且分布式的先進節點硅供應鏈。除此之外,我們需要一套注入人工智能的技術,將更廣泛的生態系統連接在一起,以便能夠創建所有的設計內容。”
原文:
https://semiengineering.com/three-way-race-to-3d-ics
關鍵詞: 3DIC