AMD申請3D堆疊散熱專利:妙用熱電效應
2019-07-02 10:32:53 太平洋電腦網但隨著堆疊元器件的增多,集中的熱量如何有效散出去也成了大問題,AMD就悄然申請了一項非常巧妙的專利設計。
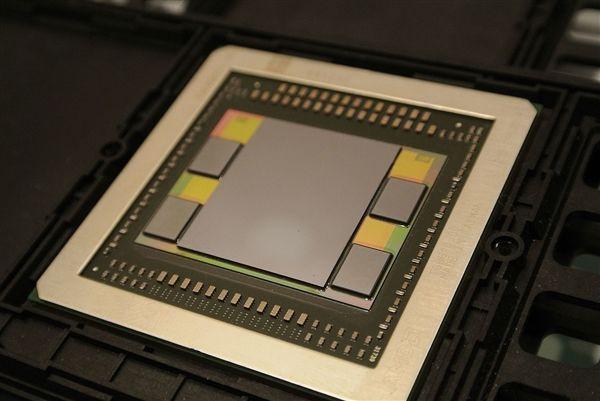
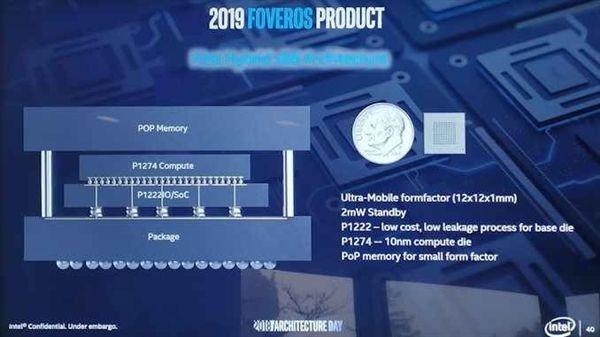
Intel Foveros立體封裝
根據專利描述, AMD計劃在3D堆棧的內存或邏輯芯片中間插入一個熱電效應散熱模塊(TEC),原理是利用帕爾貼效應(Peltier Effect)。
它也被稱作熱電第二效應、溫差電效應。由N型、P型半導體材料組成一對熱電偶,通入直流電流后,因電流方向不同,電偶結點處將產生吸熱和放熱現象。
按照AMD的描述, 利用帕爾貼效應,位于熱電偶上方和下方的上下內存/邏輯芯片,不管哪一個溫度更高,都可以利用熱電偶將熱量吸走,轉向溫度更低的一側,進而排走。
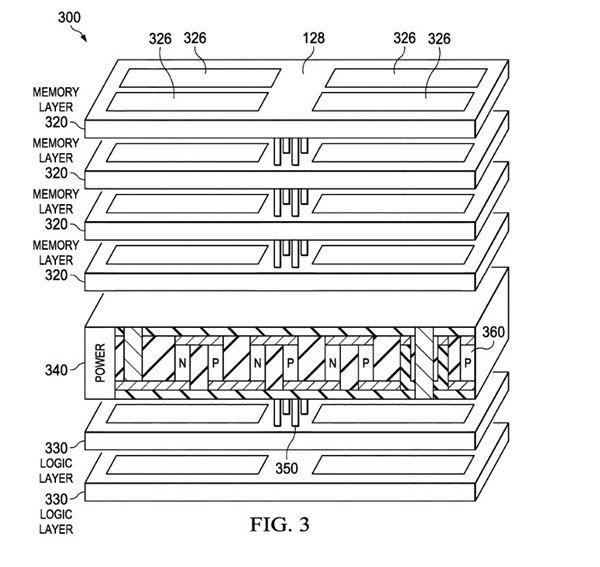
不過也有不少問題AMD沒有解釋清楚,比如會不會導致上下的元器件溫度都比較高?熱電偶本身也會耗電發熱又如何處理?
但總的來說,AMD的這個思路非常新奇巧妙,未來或許會有很光明的前景。
