EETOP消息,據外媒《Anandtech》報道,如今,最先進的芯片采用 5/4 納米級工藝制造,使用 EUV 光刻 ASML 的 Twinscan NXE:3400C(和類似)系統,具有 0.33 數值孔徑 (NA) 光學器件,可提供 13 nm 分辨率。該分辨率對于 7 nm/6 nm 節點(間距為 36 nm ~ 38 nm)和 5nm 節點(間距為 30 nm ~ 32 nm)的單一曝光技術已足夠。但隨著間距低于 30 nm(超過 5 nm 節點),3納米分辨率加雙重曝光技術,將是未來幾年內主流技術應用。
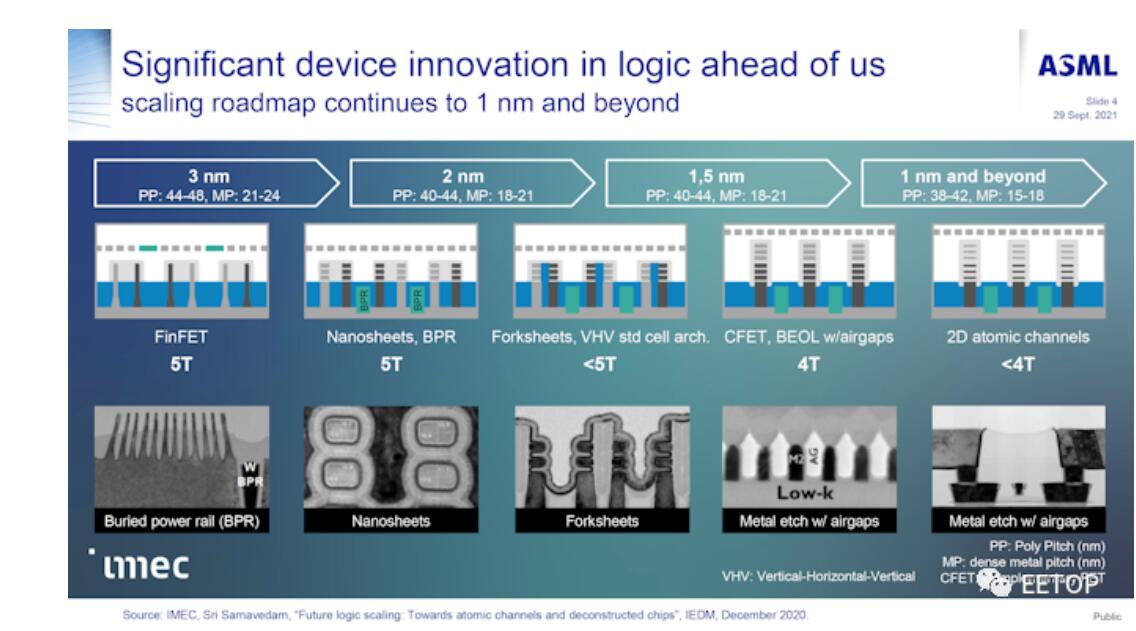
對于后 3nm 節點,ASML 及其合作伙伴正在開發一種全新的 EUV 工具——TwinscanEXE:5000 系列——具有 0.55 NA(高 NA)透鏡,能夠實現 8nm 分辨率,使3納米及更先進節點制程盡可能避免使用雙重或多重曝光。
新的高 NA 光刻機仍在開發中,預計它們將非常復雜、非常龐大且價格昂貴——每臺的成本將超過 4 億美元(約合27億RMB)。據悉光運送該設備就需動用三架波音747。High-NA EUV 光刻曝光設備不僅需要新光學器件,還需要新光源材料,如德國蔡司 (Carl Zeiss) 真空制造的拋光、超光滑曲面鏡組成的光學系統,甚至還需要更大廠房容納機器,都需要龐大投資。 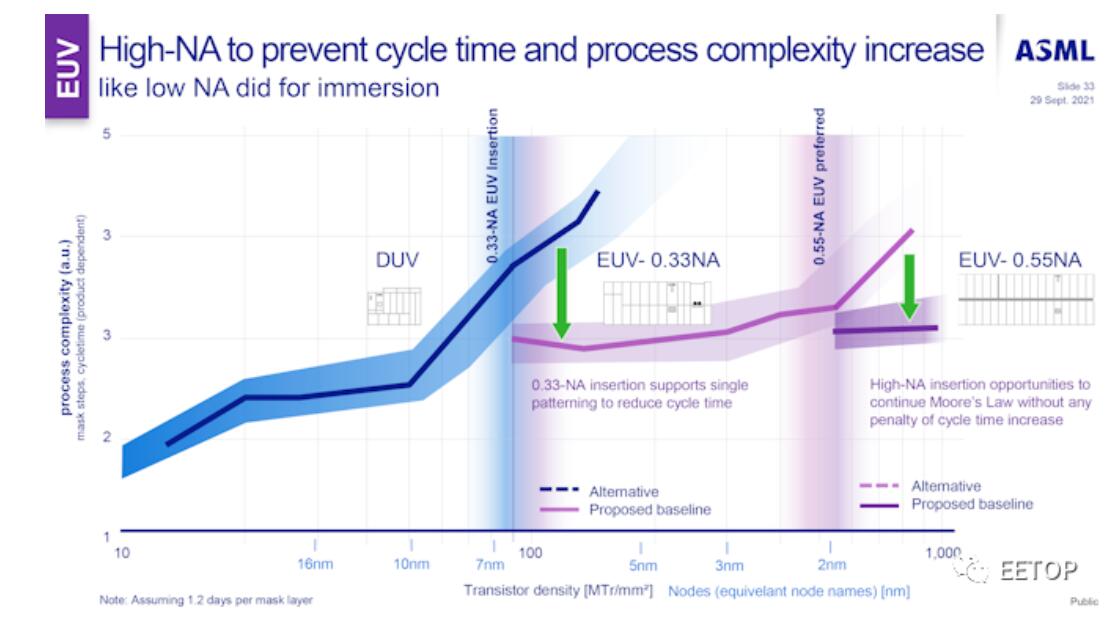
但為了保持半導體的性能、功率、面積和成本 (PPAc),領先的邏輯芯片和存儲設備制造商愿意采用新技術,而高 NA EUV光刻機對于后 3nm 至關重要節點。因此,對高 NA s設備的需求非常高。
幾周前,ASML 透露 ,它在 2022 年第一季度收到了來自邏輯和 DRAM 客戶的高 NA Twinscan EXE:5200 系統(EUV 0.55 NA)的多份訂單。
《路透社》報道,ASML說明取得5筆High-NAEUV微影曝光設備先導型訂單,預定2024年交貨。 另有超過5筆訂單是2025年開始交貨的量產型型號。早在 2020~2021 年,ASML就表示收到三家客戶 High-NA EUV 微影曝光設備意向訂單,數量多達 12 套系統。可肯定的是,英特爾、三星和臺積電等必然拿下 2020~2021 年試生產的 High-NA EUV 光刻曝光設備。ASML已為Imec生產首個High-NA EUV光刻曝光設備,預計2023年完成用于研發。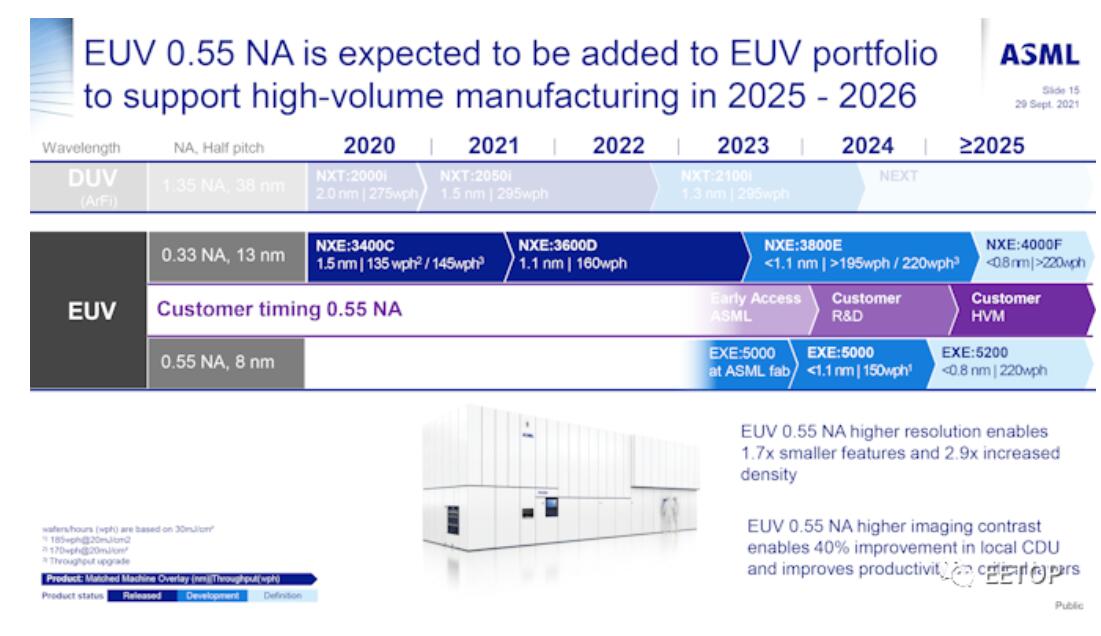
不久前,ASML執行長Peter Wennink表示,High-NA EUV光刻光曝光設備取得良好進展,已開始于荷蘭新無塵室打造第一部High-NA EUV光刻曝光設備。 第一季度ASML收到多份EXE: 5200訂單,5月也收到其他EXE:5200訂單。 目前有三個邏輯芯片和兩個內存客戶訂單。 未來設備交貨將為曝光微影技術性能和生產力提供更多發展。
ASML的 TwinscanEXE:5200 比常規Twinscan NXE:3400C 機器復雜得多,因此構建這些工具需要更長的時間。該公司希望在未來中期能夠提供多達20 臺 High-NA 系統,這可能意味著其客戶將不得不為這些機器展開競爭。“我們還在與我們的供應鏈合作伙伴討論,以確保在中期內擁有約20 個 EUV0.55NA 系統的產能。”Wennink說。 英特爾率先采用預生產設備
到目前為止,唯一確認使用ASML 的High-NA 工具的工藝技術是 英特爾的 18A 節點,該節點曾計劃在 2025 年進入量產,大約是 ASML 開始交付其生產的 High-NAEUV 系統的時間。但最近英特爾將18A 的生產時間推遲到2024 年下半年,并 表示 可以使用 ASML 的 TwinscanNXE:3600D 或NXE:3800E 進行18A 制造,這大概是通過多重曝光模式來實現。到目前為止,唯一確認使用ASML High-NA EUV光刻曝光設備的是英特爾18A制程節點。英特爾計劃2025年進入批量生產階段,ASML也約那時開始交付High-NA EUV設備。但最近英特爾已將18A生產規劃延到2024年下半年,并表示可用ASML Twinscan NXE:3600D或NXE:3800E生產,顯示可能借多重曝光模式達成High-NAEUV設備的效果。 雖然英特爾18A制程技術會大大受惠于High-NA EUV微影曝光設備,但也代表完全離不開Twinscan EXE:5200設備。雖然英特爾18A制程技術不一定需要新機器,但多重曝光模式意味必須冒更長產品生產周期、更低良率以更低獲利風險,這將使英特爾更難與對手競爭。英特爾一定也希望 18A 制程節點盡快到來,重拾往日榮耀,好從臺積電手中奪回晶圓代工領頭羊的地位。其他領先半導體制造商臺積電、三星、SK海力士和美光等,也不可避免采用High-NA EUV微影曝光設備生產,但唯一問題是究竟何時會發生。